|
事例紹介パワーデバイス関連 事例
|
|||||||||||||||
|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|
事例2 | パワーサイクル試験
原理 短時間に接合温度を上昇・下降させて半導体素子に熱ストレスを与えることにより、信頼性確認および素子の破壊寿命を推定する。
基本構造 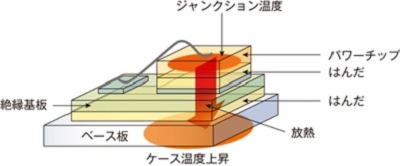
試験に必要な情報
アプリケーション
ΔTjパワーサイクル試験事例 ●熱抵抗測定結果
試験後に熱抵抗が1.3倍に上昇しました。
|
|||||||||||||||
 |

|
事例紹介パワーデバイス関連 事例
|
|||||||||||||||
|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|---|
事例2 | パワーサイクル試験
原理 短時間に接合温度を上昇・下降させて半導体素子に熱ストレスを与えることにより、信頼性確認および素子の破壊寿命を推定する。
基本構造 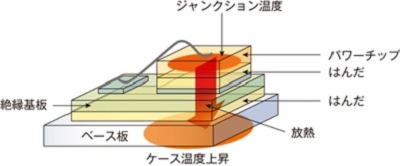
試験に必要な情報
アプリケーション
ΔTjパワーサイクル試験事例 ●熱抵抗測定結果
試験後に熱抵抗が1.3倍に上昇しました。
|
|||||||||||||||
 |