種々の手法における拡散層評価技術
目的・用途に応じた拡散層の評価が実施できます!
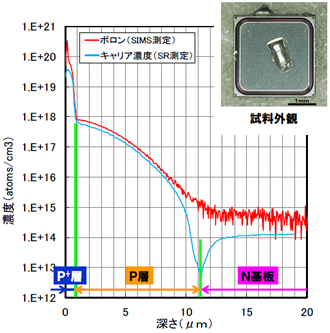
アノード部のSIMSおよびSRプロファイル
|
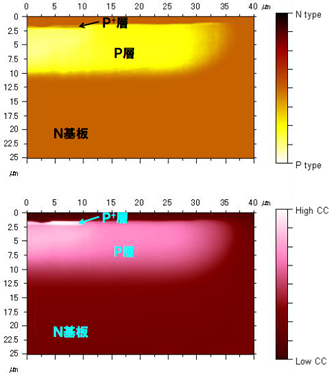
アノード終端部のSCM像(上) / SMM像(下)
|
SIMS測定よりドーパントプロファイルを、SR測定よりキャリア濃度プロファイルを得ることができます。
デバイスの微小領域(数~数十um)においては、SCM/SMM観察にて拡散層を評価できます。
試料・目的に応じた拡散層評価が可能です!
トレンチゲートMOSFET断面のSCM/SMM観察
SCM観察よりPN極性情報を、SMM観察よりキャリア濃度情報を含む拡散層評価ができます。
SCMとSMMを組合せることで、構造をより明確に観察できます!

拡散層の断面SEM観察(N-ch MOSデバイス)
【試料作製法】
埋込み→ 研磨 → エッチング→ SEM観察
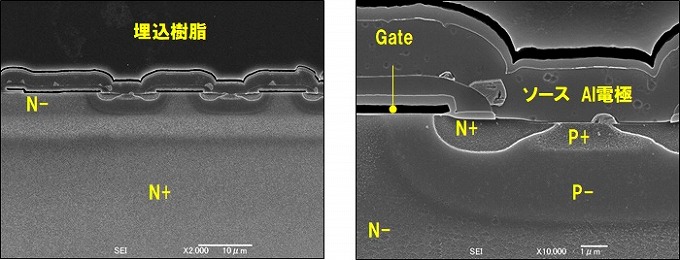
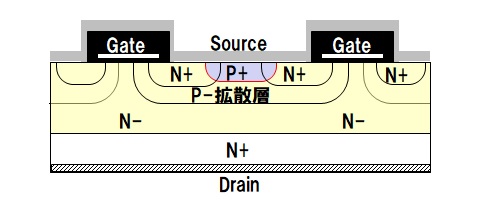 デバイスの構造模式図
デバイスの構造模式図
|
