事例2 | SR測定による拡散、EPI/SUB評価
拡散層の評価やウェハ仕様(EPI/SUB層)の確認が可能。
ダイオード素子のアノード拡散、及びEPI/SUB層の評価としてSR測定を行う。
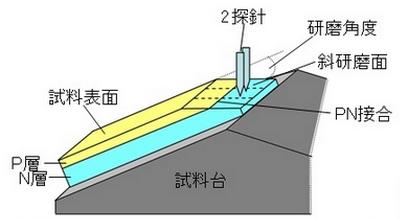 |
|
斜研磨したSiウエハにて、深さ方向に2深針をコンタクト
させ、
広がり抵抗を測定する。
得られた広がり抵抗を解析して、ウエハの深さ方向の
比抵抗、
キャリア濃度プロファイルを計算する。
|
【得られる情報】
●深さ方向キャリア濃度プロファイル
●深さ方向比抵抗プロファイル
⇒PN接合深さや、N+層とN-層の境界 の深さ、各層のキャリア濃度などの 情報が得られる。 |
【測定試料】
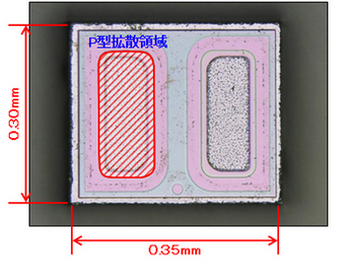 |
【キャリア濃度及び抵抗率プロファイル】
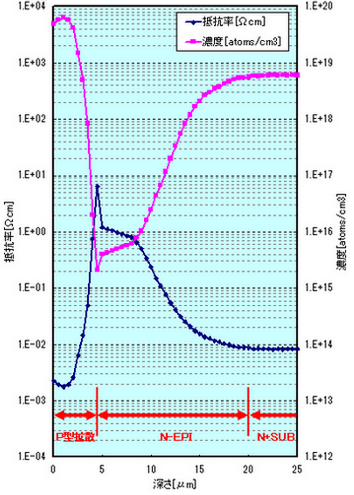 |
【測定結果】
| P型拡散 |
濃度 |
6.4×1019 atoms/cm3 |
| 深さ |
4.5 μm |
| N-EPI |
低効率 |
約1.0 Ωcm |
| 厚さ |
20 μm |
| N+SUB |
比抵抗 |
約0.01 Ωcm |
|
微小チップでも、拡散層やEPI/SUB構造の濃度や深さが確認可能。

|
