|
金ワイヤとICアルミパッドの接合状態について、ワイヤボンディング後と高温保存後での断面解析を行う。
1.断面観察
断面加工(加工ダメージの少ないドライエッチング)
断面観察(FE-SEM高倍率チャネリング像観察)
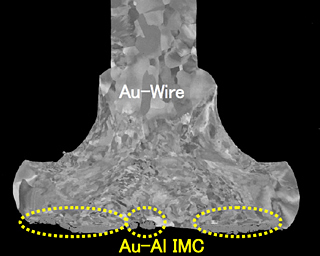
図1 ワイヤボンディング後のチャネリング像
|
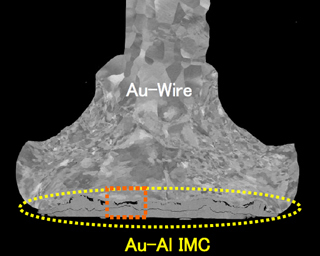
図2 高温保存後のチャネリング像
|
2.電子後方散乱解析像法(EBSP)
断面加工(加工ダメージの少ないドライエッチング)
EBSP解析(結晶方位、歪み解析)
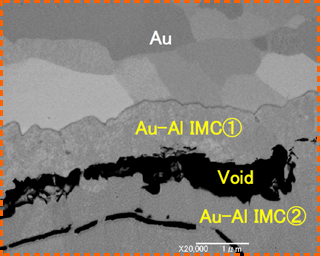
図3 高温保存後の金属間化合物拡大像
|

図4 金ワイヤ熱処理後の断面EBSP像
|
断面観察(ドライエッチング断面加工 → FE-SEMチャネリング像観察)
○ワイヤボンディング後:金ワイヤとアルミパッド界面には金属間化合物が部分的に形成される。
○高温保存後:金ワイヤとアルミパッド界面全体に渡り、組成比が異なると推測される複数の金属間化合物層が形成され、それらの界面にはボイドが散見される。
電子後方散乱解析像法(ドライエッチング断面加工 → EBSP解析)
EBSPを用いて金ワイヤ断面の結晶方位や歪みについて解析することができ、キャピラリの直下では金の組織が微細化していることが確認される。

|
