TEM[テム] : Transmission Electron Microscope
薄くした試料に加速した電子線を照射すると、電子は試料を透過する際に散乱・吸収・回折される。
これら透過した電子を蛍光板やCCDカメラに拡大投影して観察する。
金属・半導体、セラミック・ガラス
縦x横:3mmφ
厚み:50μm以下
※観察箇所は50~200nmの薄膜
像観察:明視野像、暗視野像、高分解能像、電子回折図形
EDX :点分析、元素マッピング
半導体デバイスの膜厚・格子欠陥評価
オーミックコンタクト界面の高分解能観察
金属間化合物の同定
サンプルの構造・構成元素および着目箇所・元素
○LaB6電子銃、加速電圧300kVで高分解能観察が可能。
【分解能0.10nm(格子像)、0.18nm(粒子像)】
○共用ホルダーを用いて、FIB~STEM~イオンミリングのリンケージが可能。
○特殊制限視野絞りを搭載し、最小15nmφの電子回折図形が取得可能。
○雰囲気遮断ホルダーを用いて、非暴露でFIB加工→高分解能観察が可能。
○EDX検出器を搭載し、微小領域(10nm)の元素分析が可能。
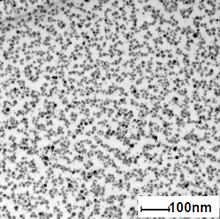 明視野像
明視野像
・形状、大きさ |
 暗視野像
暗視野像
・特定結晶面の分布 ・結晶配向性 |
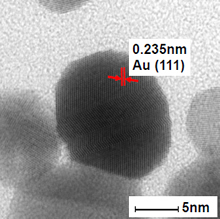 格子像
格子像
・異相界面の原子配列 ・結晶格子欠陥 |
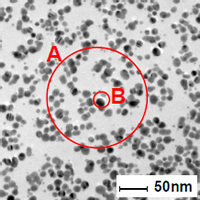 電子回折図形
電子回折図形
・結晶構造 ・析出物の同定 |
A:一般的な制限視野
絞りの視野領域
(最小:約200nm) 
|
B:特殊制限視野絞りの
視野領域(約30nm)
(※最小視野:約15nm) 
|
シミュレーション
Au<011>

|
| 一般的な制限視野回折は多数の粒子の回折図形となるためリング状となるが、特殊制限視野絞りの適用でおよそ1粒子の回折図形が取得可能。 |
|
|
|
Si結晶格子欠陥観察 |
Si酸化膜測定 |
Cu表面酸化膜の同定 |
回折図形
シミュレーション |

|
