STEM[ステム]: Scanning Transmission Electron Microscope
EELS[イールス] : Electron Energy-Loss Spectroscopy
薄片化した試料に電子を照射し、試料中を透過もしくは試料により散乱した電子を利用して、観察・分析を実施する。
揮発性材料・磁化を帯びた材料
直径3mmφ以内、厚み0.5mm以内
マイクロサンプリングした薄片
縦x 横x 厚み:8μm x 5μm x 100nm前後
微粉末 ミクロトーム切片
○空間分解能0.204nmにより、nmオーダーの測長や微小領域(2nm程)の分析が可能。
○ホルダーリンケージにより、FIB装置間の移動が可能。
○360度回転ホルダーによりデータ取得および三次元再構築することで、
多様な方向から立体構造の観察が可能(トモグラフィー解析)。
○雰囲気遮断試料ホルダーを用いて、水分・酸素・窒素脆弱材料の解析が可能。
○EDXにより、元素(B~U)の同時定性分析や半定量値を算出することが可能。
○EELSにより、軽元素(Liなど)分析や化学結合状態の解析が可能。
像観察:二次電子像(SE)・散乱電子像(ZC)・透過電子像(TE)・電子回折図形
三次元再構築:トモグラフィー解析
EDX: 点分析・線分析・元素マッピング
EELS: 点分析・線分析・元素マッピング
IC・メモリなどの微細構造解析
Li電池の軽元素分析
断面構造および着目箇所、構成元素、予想される化学組成情報
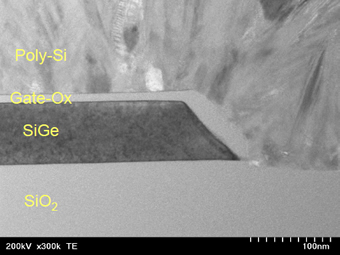
透過電子像(TE像) |
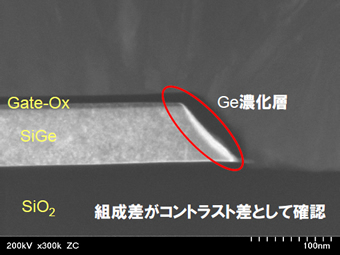
散乱電子像(ZC像) |
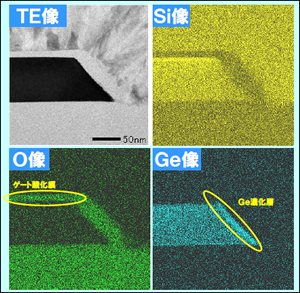 Au-Wire立体像構築結果
Au-Wire立体像構築結果
|
観察モードの特徴
TE像:Transmission Electron Image
結晶粒・結晶欠陥の観察に適する。
重い物質が存在する箇所は、透過能が
低下するため、コントラストが低下する。
ZC像:Z Contrast Image
試料の組成に応じたコントラスト、つまり
重たい元素・物質ほど明るく観察され、
そのコントラストは原子番号の2乗に
比例すると言われている。
EDXマッピング像:Energy Dispersive X-ray Spectrometry
電子線を照射した際に励起される特性X線を
エネルギー値で分光・検出することにより、
照射領域の構成元素を定性・定量する分析手法。
点分析,ライン分析および面分析が可能。 |
分析事例(トモグラフィー解析事例:ホール側壁の微粒子)
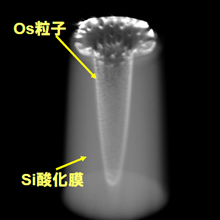 3次元再構築像 |
 任意の断面が観察可能 |
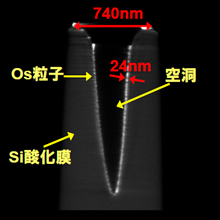 任意箇所の測長可能 |
|
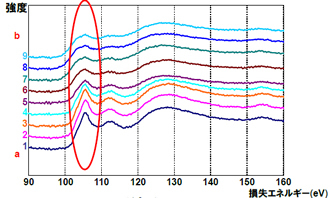
Si-Lエッジ付近のEELSスペクトル |
散乱電子像(ZC像)
EELS分析箇所(a-b間)
|
EDXでは、各構成元素「Si」と「O」の情報のみである。
EELSスペクトルでは、
構造の違いに起因するピークの変化が確認できる。 |
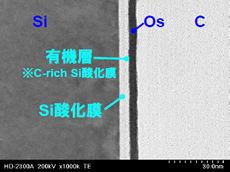
透過電子像(TE像) |
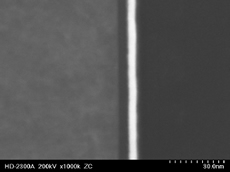
散乱電子像(ZC像) |
TE像とZC像では、Si酸化膜と有機層の違いを確認できない。 |
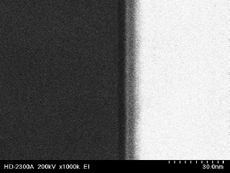
EELS C-マッピング |

EELS O-マッピング |
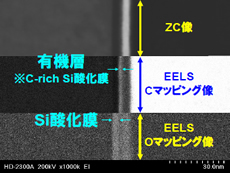
EELS ZC/C/O-マッピング |
EELS 元素マッピングは、1分以内でデータ取得可能である。
また、観察中に元素マッピングへ信号を切り替えることができ、有機層とSi酸化膜の違いが鮮明に
確認できる。
|

|
