FIB: FocusedIonBeam
SEM: ScanningElectronMicroscopy
断面加工機構(FIB)と表面観察機構(SEM)を一体化した装置。本装置はFIB, SEM各々のビームが58°で
交差する構成のため、イオンビームで加工した断面をいつでもSEM観察することができる。
【FIB】
二次電子像分解能:5nm@40kV
【SEM】
二次電子像分解能:1.0nm@15kV
試料サイズ:最大30 mmφ
高さ制限:最大22 mm
○マイクロサンプリング機能により、特定微小部のTEM用試料作製が可能。
○Mill&Monitorにより、連続断面SEM(BSE)像の撮影が可能。
○EDS分析・EBSD分析により、元素分析・結晶方位解析が可能。
○EBデポジション機能により、ダメージフリーでのデポジションが可能。
○雰囲気遮断ホルダーにより、大気非暴露でのFIB加工・SEM観察が可能。
※BSE:BackScattered Electron 、EB:Electron Beam
Mill&Monitor機能を用いた連続断面SEM像撮影(W/B接合部観察)
↓↓↓画像をクリックして下さい↓↓↓
連続断面動画が再生されます。
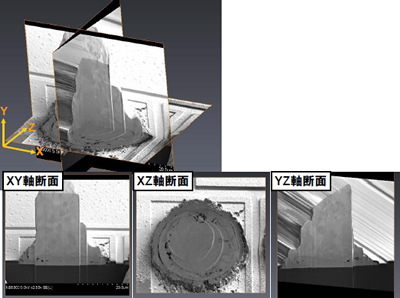
・三次元再構築により、実際のFIB加工方向のみならず、
任意角度から断面SEM像が取得可能。
・立体構造を容易に把握することが可能になるほか、
任意領域の体積や表面積の計測も可能。
|
Au-Wire立体像構築結果
 |
ボイド箇所抽出結果
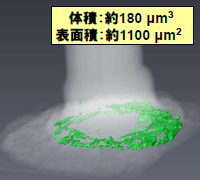 |
 ■
■Auスタッドマイクロバンプ
九州大学システム情報科学研究院
浅野先生ご提供試料
3次元的な接合性の評価が可能。
未接合、ボイドの有無等のディフェクトを可視化。
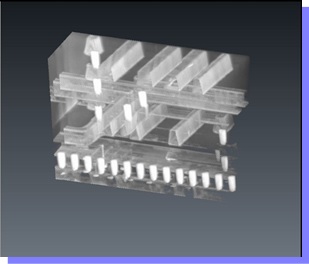 ■
■LSI配線構造
3次元構造が一目瞭然。
他社チップ構造解析、出来栄え確認等に有効。

パワーデバイスパッケージ ボンディング直下不具合箇所 三次元解析事例
裏面OBHRUCH測定と裏面からの故障個所FIB断面解析での連続断面像取得により、
故障個所を三次元的に詳細に解析することが出来ます。
ワイヤー直下での破壊を確認。
破壊箇所は特定できても物理解析は非常に困難。
⇒ Dual-FIBが有効
メタルを除去せずに破壊の状態を確認は可能、
但し、任意断面の観察だけでは、破壊の形状は不明。
⇒ 三次元解析が有効
FIB-SEM(Dual-FIB)であれば、加工断面の状態を、リアルタイムに確認可能です。
そのため、特定微小部であっても、目的とする断面の観察が可能となります。
|
取得した連続断面像を三次元再構築し破壊部に着色することで
形状を明確にすることができます。
|
↓↓↓画像をクリックして下さい↓↓↓
立体再構築動画が再生されます。
 |
| 