装置1 | 走査電子顕微鏡/エネルギー分散型X線分析
SEM[セム]: Scanning Electron Microscope
加速した電子線を細く絞り試料に照射・走査させ、試料より発生した二次電子や反射電子を画像化して
観察する。
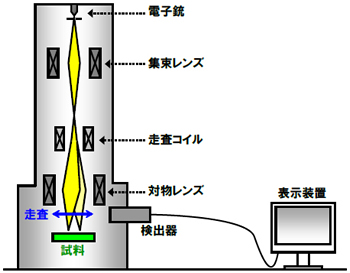 |
種々の検出器を搭載することによって様々な表面像観察が可能。
・二次電子検出器
⇒ 二次電子像観察(表面形状・凹凸)
・反射電子検出器
⇒ 反射電子像観察(組成差・結晶方位差)
|
◎観察可能な材料
金属、半導体、セラミック、
無機・有機複合材料、磁性体、
有機材料等
※ 絶縁試料や樹脂包埋品の観察には
表面に導通処理が必要。
|
|
装置名 |
HITACHI S-4300SE |
JEOL JSM-6335F |
JEOL JSM-6700F |
電子銃 |
熱陰極FE(ショットキー) |
冷陰極FE |
対物レンズ |
アウトレンズ |
セミインレンズ |
サンプル
サイズ |
樹脂包埋
(直径x高さ) |
Φ26mmx15mm |
その他
(縦x横x高さ) |
100mmx100mmx15mm |
100mmx100mmx30mm |
100mmx100mmx 4mm |
付帯分析機器 |
EBSD, EDX |
EDX |
・二次電子像
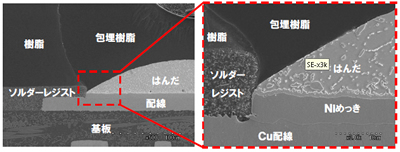
凹凸によるコントラストで、はんだ中の化合物の形状など
表面状態を観察できる。 |
・反射電子像
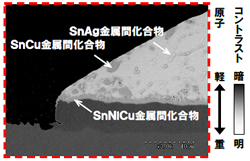
原子の重さによるコントラストで
はんだなどの元素組成差を観察できる。 |
EDX[イーディーエックス]: Energy Dispersive X-ray Spectrometry
加速した電子線を細く絞り試料に照射し発生した特性X線を検出する。
特性X線は元素に固有のエネルギーを持つことから、構成元素の同定、
分布などを知ることができる。
○分析スポット径:数μm程度
○検出元素:5B~92U
○検出感度:1000ppm程度(= 0.1%)
○導体だけでなく、絶縁物試料分析可能。
※絶縁試料や樹脂包埋品の観察には表面に導通前処理が必要
○定性分析 ※ポイント、エリアで指定可能
○半定量分析
○ライン分析
○マッピング
異物、析出物、腐食生成物などの成分特定
鉛フリーはんだ、金属間化合物などの組成調査

|
