|
TOF-SIMS[トフ-シムス] : Time Of Flight-Secondary Ion Mass Spectrometry
試料表面に一次イオン(Bi3++)を照射し、発生する二次イオンの検出器までの飛行時間とその個数を測定する。
金属・半導体材料、セラミック・ガラス、、プラスチック・紙、液体・揮発性有機成分
縦x 横:5cm x 5cm以下
厚み:1cm以下
重さ:200g以下
※周囲に凹凸がないこと。
○ 電子中和銃搭載により有機材料・無機材料共に分析可能。
○ スパッタガン(Cs,O2)搭載で深さ方向分析が可能。
○ 幅広い質量領域のスペクトルを瞬時に取得。(追加解析が可)
○ 4cmx4cmまで広域イメージングが可能。【通常の最大分析領域:500x500μm□】
○ 有機成分もライブラリーやRef.サンプルから推定が可能。
○ 雰囲気遮断システムを搭載。水分・酸素脆弱サンプルの分析が可能。
表面定性分析・表面イメージング
深さ方向分析・断面イメージング
広域イメージング
ウエハ表面汚染調査
金属表面のシミ・変色分析
金属多層膜の組成評価
サンプルの構造・組成・プロセス上使用されている薬剤名(MSDSシート)
Ref.(比較対象)となるサンプルの情報・着目元素、成分等
深さ方向分析 金属層中のOおよび金属酸化物強度比較
層構造:A/B/C/D(Sub.)
C層中の
O:O[NG] > O[OK]
COx:
COx[NG] > COx[OK]
NG品のC層は
OK品より酸化している。
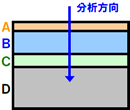 |
|

|
