Analysis & Evaluation SectionCase Study
事例紹介半導体解析-3
SCM、sMIM、MFMを用いたチップ評価解析
SCM、sMIMを用いたSiウエハ拡散層評価
SCM:
変調電圧を印加しているプローブを試料表面に接触させながら走査し、プローブ直下のキャパシタンスの変化をイメージングする。PN極性とともに拡散層の形状を確認できる。
sMIM:
プローブを介して入射させたマイクロ波の反射波を測定し、入射波と反射波の振幅や位相の差から試料表面のインピーダンスを算出し、イメージングする。キャリア濃度の情報とともに拡散層の形状を確認できる為、観察面内での濃度分布を推定できる。
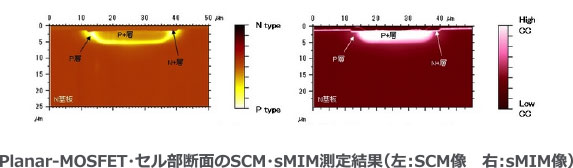
SCM像とsMIM像を組み合わせることで、
より詳細な拡散層構造の特定が可能となる。
より詳細な拡散層構造の特定が可能となる。
MFM [エムエフエム]
Magnetic Force Microscope磁性膜でコートされたプローブを試料から浮かせた状態で走査すると、試料表面の磁場によって、プローブは相互作用(引力や斥力)を受ける。この相互作用をマッピングする。
MFMを用いた磁気テープの磁界分布観察

観察面内における磁力の相対的な強度分布をイメージングできる。
チップ拡散層評価(SR)
拡散層の評価やウェハ仕様(EPI/SUB層)の確認が可能。
目的
ダイオード素子のアノード拡散、及びEPI/SUB層の評価としてSR測定を行う。
SR測定の原理

測定試料、及び結果(キャリア濃度プロファイル)
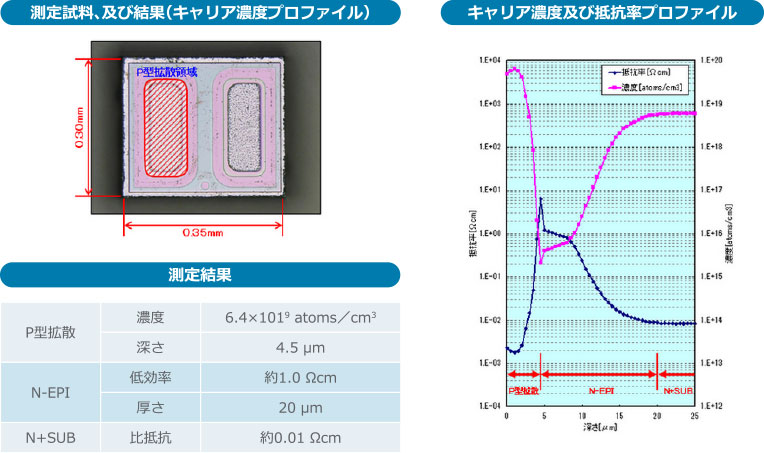
STI構造の高分解能観察(TEM)
STI [エスティーアイ] Shallow Trench Isolation
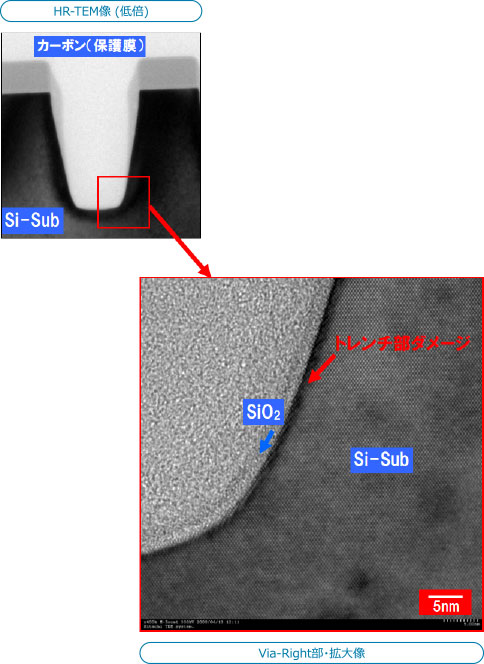
STI構造のSi-Sub格子、トレンチ部ダメージを原子レベルで確認可能。
リバースエンジニアリング(回路抽出技術)
回路図・プロセス情報等の解析もお任せ下さい!
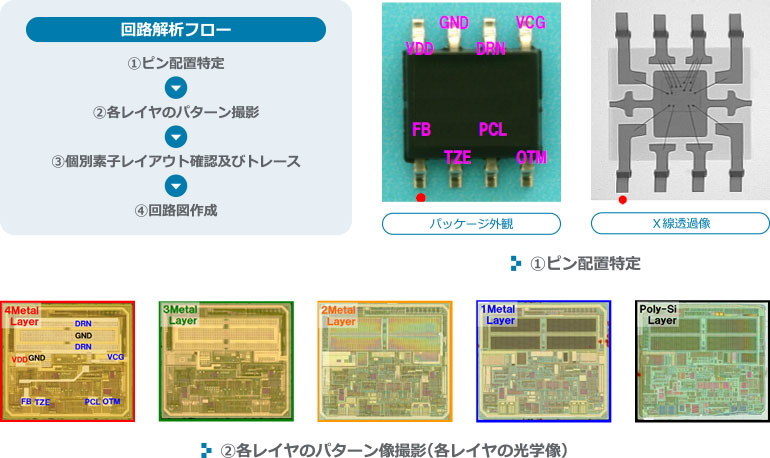
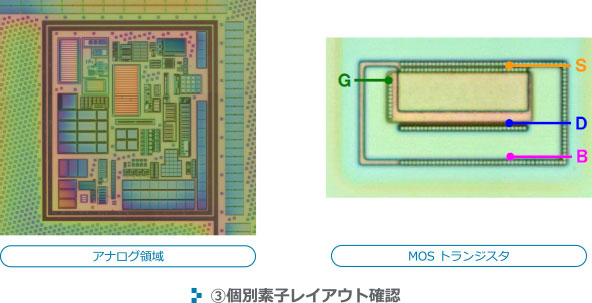

アウトプット
- プロセス情報(積層数、ゲート長等)
- 機能ブロック配置図
- 個別素子情報
- 個別回路図




