Analysis & Evaluation SectionCase Study
事例紹介半導体解析-2
バンプ接合断面解析(SEM/EDX)
物理解析サービス(断面SEM/EDX/EBSD)
金属、樹脂、複合材あらゆる材料の断面解析にご対応致します!
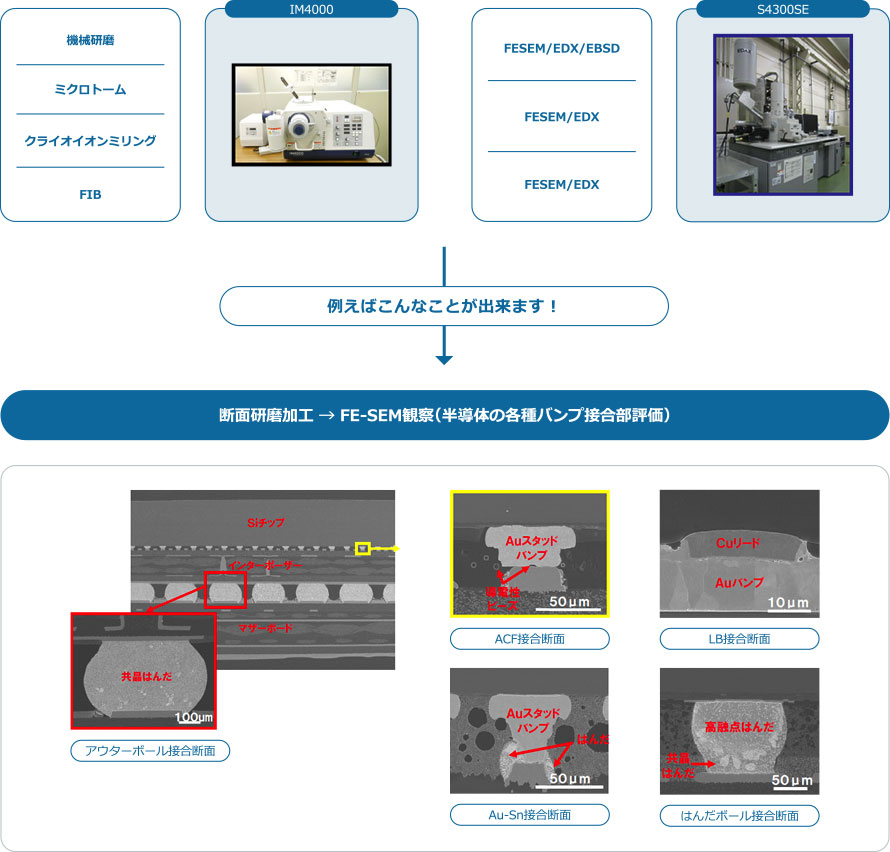

反射電子像の組成コントラストを元素マッピングにより確認可能。
ワイヤボンディングの断面構造解析(3D-FIB)
Auワイヤー接合界面の腐食部解析 (FE-EPMA)
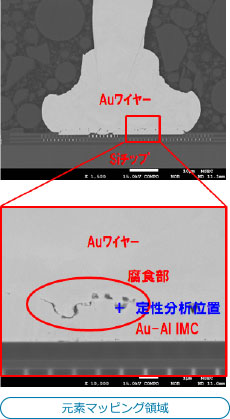
FE-EPMA元素マッピング
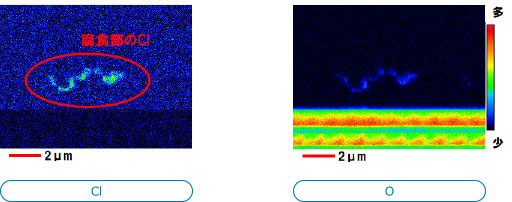
EDX元素マッピング

FE-EPMA定性分析・半定量結果

半定量結果 (Atm%)
| Au | Al | O | Cu | Cl | Si |
|---|---|---|---|---|---|
| 56.82 | 23.73 | 14.51 | 2.70 | 1.06 | 1.18 |
註:Cは除いて算出
EDXでは確認できない腐食部のClが、
FE-EPMAでは明瞭に確認することが可能。
FE-EPMAでは明瞭に確認することが可能。
表面分析・深さ方向分析(XPS/TOF-SIMS)
金属積層膜のXPS分析
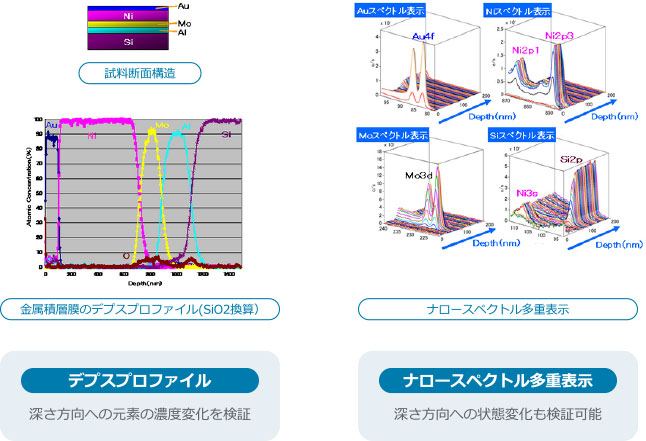
金属積層膜のTOF-SIMS分析
TOFSIMSは最表面分析法の一つで、金属化合物の状態や有機化合物の推定が可能。
また、スパッタガンを併用することでDepth Profiling(深さ方向分析)が可能となり、金属の多層構造の状態評価等に用いられる。
分析アプリケーション
①表面定性分析 ②表面イメージング ③Depth Profiling(深さ方向分析) ④断面Depthイメージング

イメージ像→各成分の位置情報(表面・深さ方向分布)を視覚的に表示。