Analysis & Evaluation SectionCase Study
事例紹介半導体解析-1
はんだボール表面酸化膜解析(AES)
目的
BGAの接合不良はんだボールについて、ソルダビリティーの低下要因となる表面酸化膜をFE-AES分析により解析した。
分析方法
1.FE-AES分析
表面定性分析と深さ方向による酸化膜厚の測定
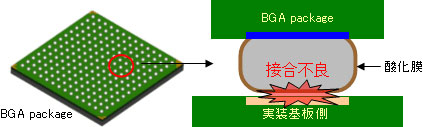
図1 接合不良の模式図

図2 不良ボール FE-AES表面スペクトル

図3 不良ボール デプスプロファイル
まとめ
FE-AES深さ方向分析により、不良ボールには約14nm(SiO2換算)の表面酸化膜が形成されていることが明らかとなった。
BGAパッケージのはんだボールのように絶縁物に囲まれたものでも、FE-AESにより分析が可能である。
金ワイヤボンド接合部の断面解析(EBSD)
目的
金ワイヤとICアルミパッドの接合状態について、ワイヤボンディング後と高温保存後での断面解析を行う。
分析方法
1.断面観察
断面加工(加工ダメージの少ないドライエッチング)
断面観察(FE-SEM高倍率チャネリング像観察)
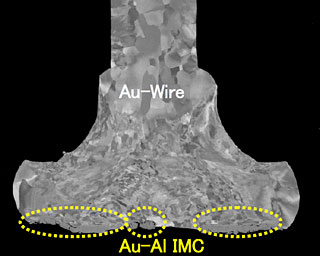
図1 ワイヤボンディング後のチャネリング像
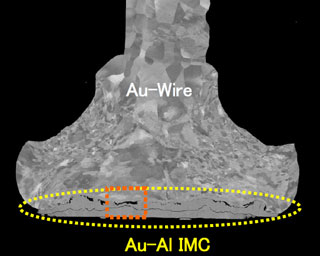
図2 高温保存後のチャネリング像
2.電子後方散乱解析像法(EBSP)
断面加工(加工ダメージの少ないドライエッチング)
EBSP解析(結晶方位、歪み解析)
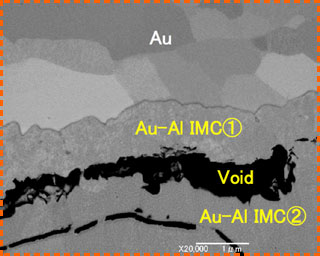
図3 高温保存後の金属間化合物拡大像

図4 金ワイヤ熱処理後の断面EBSP像
まとめ
断面観察(ドライエッチング断面加工 → FE-SEMチャネリング像観察)
- ワイヤボンディング後:金ワイヤとアルミパッド界面には金属間化合物が部分的に形成される。
- 高温保存後:金ワイヤとアルミパッド界面全体に渡り、組成比が異なると推測される複数の金属間化合物層が形成され、それらの界面にはボイドが散見される。
電子後方散乱解析像法(ドライエッチング断面加工 → EBSP解析)
EBSPを用いて金ワイヤ断面の結晶方位や歪みについて解析することができ、キャピラリの直下では金の組織が微細化していることが確認される。
Agめっき表面の変色部解析(FE-AES/XPS)
表面分析サービス(FE-AES/μ-XPS)
nmオーダーの極表面における表面分析アプリケーションのご紹介

表面から数nm~数十nm程度の元素の存在を確認する事が可能。
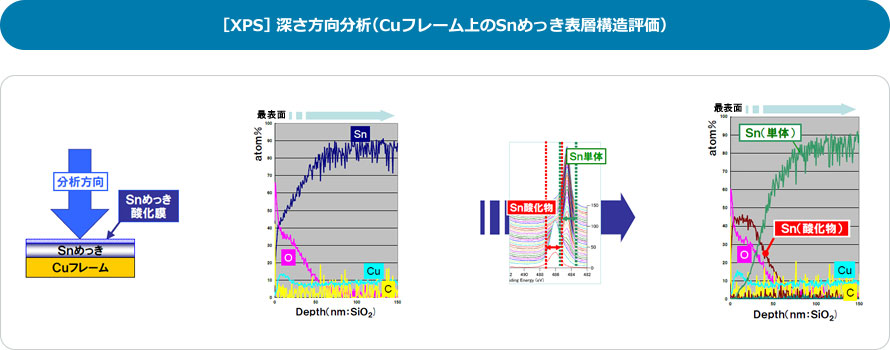
化学状態をデプスプロファイルに反映することで、詳細に層構造を把握することが可能。
Auめっき表面変色部解析(TOF-SIMS)
表面分析サービス(TOF-SIMS)
nmオーダーの極表面における表面分析アプリケーションのご紹介
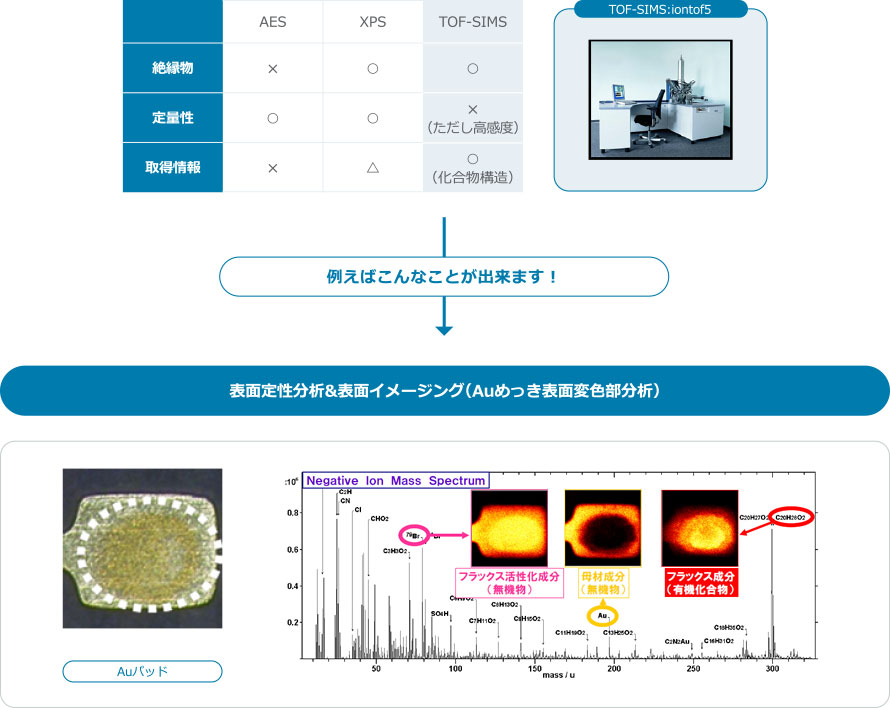
有機物・無機物問わず同時にかつ詳細に高感度で分析可能。
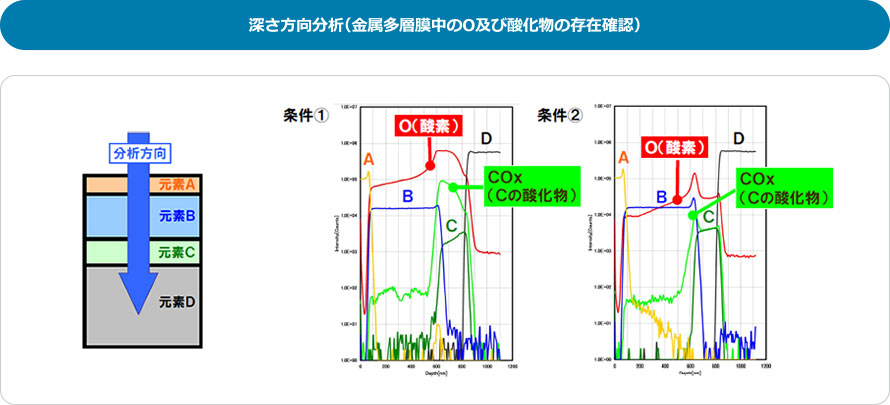
単体元素だけで無く、化合物においても高感度で深さ方向分析を実施する事が可能。




