Analysis & Evaluation SectionCase Study
事例紹介パワーデバイス解析-3
パワーデバイスの過渡熱抵抗測定
測定条件
- 測定サンプル:デュアルIGBTモジュール製品
- 測定器:DVFN810ZB(キャッツ社製)
- 測定モード:ΔVceモード(IGBT1素子発熱)
- 装置設定:VCE19V、IE7A、IM90mA、GATELIMIT18V、PowerTime1sec、DT500us
- 水冷コールドプレート:130×130×30mm
熱抵抗値算出
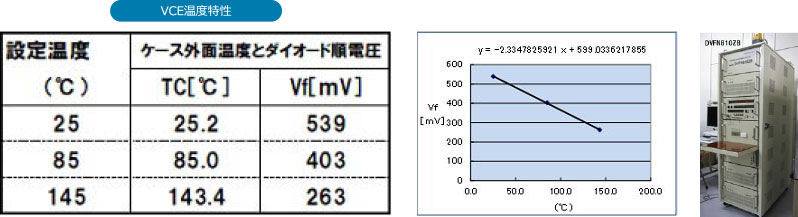
熱抵抗を明らかにするはジャンクション温度を把握しなければなりませんが、直接測定ができません。しかし、ダイオード順方向電圧(VF)の温度依存性によりジャンクション温度が分かります。 VFは温度の一次関数で表され、この傾きがKファクタ となります。

熱抵抗測定結果
| 風速(m/s) | 0 | |
|---|---|---|
| サンプルNo. | チップ [℃] | θ Jc[℃/W] |
| IGBT | 68.182 | 0.226 |
Kファクタを用いてチップ温度[℃]とθjcを算出します。
θjc=(チップ[℃]-表面温度)/(ヒーター電圧*ヒーター電流)
パワーデバイスのシリコーンゲル解析事例
パワーサイクル試験後の封止シリコーンゲルの劣化を確認する。
パルスNMR測定条件
- 測定装置:JEOL JNM-MU25(25MHz)
- 測定手法:Carr Purcell Meiboom Gill(CPMG)法
- パルス幅:90°pulse、2μs
- 繰り返し時間:4sec
- 積算回数:8回
- 測定温度:室温

試験後ゲルの劣化が進むと分子鎖が切れるため分子運動が自由にできる割合が多くなりました。
IGBTチップの故障解析
目的
Ic-Vgリーク不良IGBTチップについて故障解析を行う。
評価方法
電気的特性確認
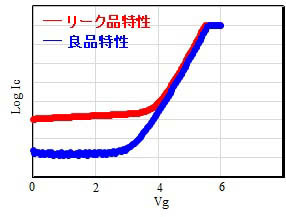
Ic-Vg特性にて、良品チップより、リーク電流が高いことが確認される。
裏面EMS解析
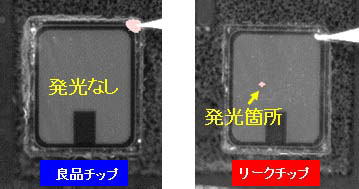
裏面EMS解析にて、セル領域内にスポット的に発光箇所が確認される。
発光箇所の断面解析
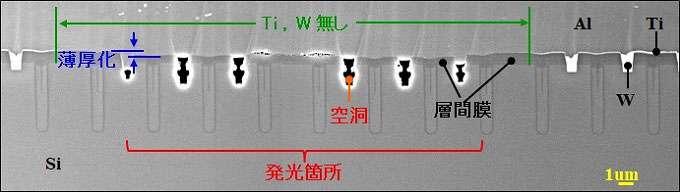
EMS発光箇所の断面解析にて、
- バリアメタル(Ti系)及びVia(W)の未形成
- 層間膜の薄厚化
- エミッタコンタクト部のSiにえぐれ形状が確認される。




