Analysis & Evaluation SectionDevice Principle
装置原理表面解析/有機分析-1
表面分析の種類と特徴
表面分析は、サンプルの状態(対象箇所・大きさ、材質)や 知りたい情報(元素、化学状態、成分・量的)によって 常々最適な手法を選定し分析を行う。
表面分析の違い①【表面に当てるものと検出している(見ている)もの】
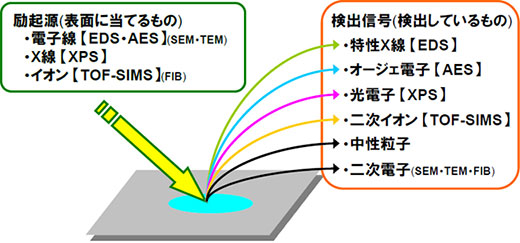
知りたい情報・分析条件・サンプルの材質等によって各種選択する。
EDS・・・エネルギー分散形X線分光法
AES・・・オージェ電子分光法
XPS・・・X線光電子分光法
TOF-SIMS・・・飛行時間型二次イオン質量分析法
表面分析の違い②【装置の特徴・性能】
| EDS | AES | XPS | TOF-SIMS | |
| 検出元素 | B~U | Li~U | Li~U | H~U |
| 検出深さ | 数μm | 数nm | 数nm | 1nm |
| 検出感度 | %オーダー | 0.1%オーダー | 0.1%オーダー | ppmオーダー |
| 得られる情報 | 元素 | 元素・化学状態 | 元素・化学状態 | 元素・イオン 分子フラグメント |
| 最小分析領域 | 数μm | 0.05μm | 50μm | 50μm |
| メリット(出来ること・得意なところ) | 簡易定性分析 定量測定 |
微小領域分析 定量測定 |
絶縁物分析 状態解析 定量測定 |
未知物質推定 微量成分の有無判定 有機分析 |
| デメリット(出来ないこと・苦手なところ) | 軽元素困難 絶縁物分析 |
サンプル制限 絶縁物分析 |
微小部分析 | 定量測定 情報量莫大 (解析困難) |
表面分析の違い②-1【図解:検出深さと分析領域】
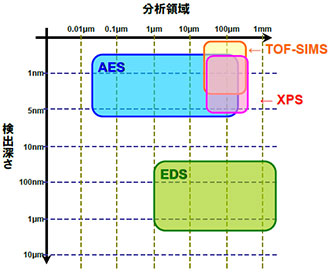
EDS:深いところ・大きい範囲の情報 → バルク分析に適している。
AES:微小領域・表層の情報 → 微小部分析に適している。
XPS・TOF-SIMS:表層の情報 → 表面分析に適している。
表面分析の違い②-2【図解:得られる情報と感度】
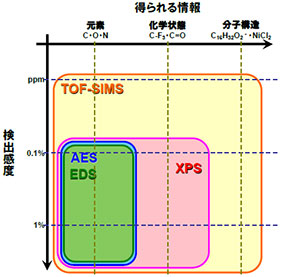
AES・EDS:元素情報、半定量比較が可能。
XPS:元素+化学状態情報、結合状態の推定が可能。半定量比較が可能。
TOF-SIMS:元素+化学状態+分子構造情報、有機成分同定が可能。微量元素分析が可能。
オージェ電子分光法
AES [オージェ]
Auger Electron Spectroscopy原理
試料表面に電子を照射し、試料の極表面から放出する電子(オージェ電子)の運動エネルギーと電子の量を測定する。
装置概要
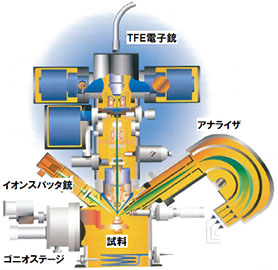
「日本電子HPより引用」
分析可能材料
金属、半導体材料、薄膜材料
サンプル制限
縦x横:5mm x 8mm以下、厚み:5mm以下
特徴
- 空間分解能:10nmにて分析可能。
- 中和銃と試料傾斜法により絶縁物試料(一部)の分析が可能。
- イオンスパッタリングにより深さ方向分析が可能。
- 深さ方向分析での深さ分解能の向上が可能。
- 広域マップ分析が可能。【最大走査範囲:20 x 20mm】
- 雰囲気遮断システム機能を搭載。
アプリケーション
スペクトル、デプスプロファイル、ラインプロファイル、広域マップ分析、オージェ像・二次電子像観察
分析事例
- 金属表面のシミ・変色分析
- 金属薄膜の分析
- 金属多層膜の元素分布
分析の際に必要な情報
サンプルの構造・組成・プロセス上使用されている薬剤名
Ref.(比較対象)となるサンプルの情報・着目元素・成分等
スペクトル分析 はんだ接合部 金属間化合物分析
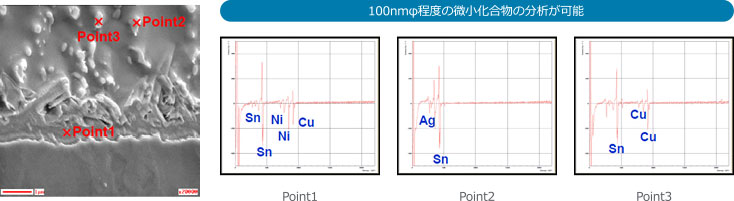
二次電子像とオージェ像 はんだ接合部 元素マッピング
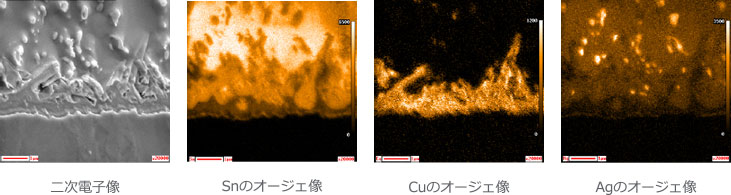
元素の分布状態を明瞭に確認
深さ方向 分析多層金属膜の深さ方法分析
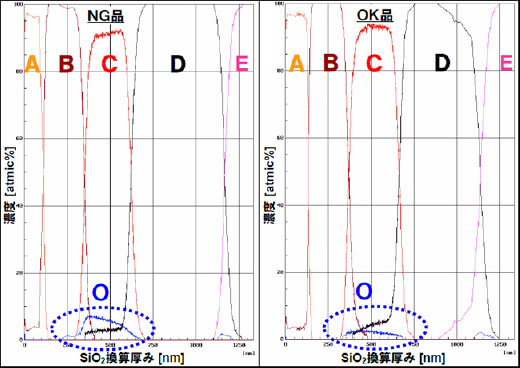
A/B/C/D/E(Sub.)
NG品のC層はOK品より酸化している。
X線光電子分光分析法
XPS [エックスピーエス]
X-ray Photoelectron SpectroscopyESCA [エスカ]
Electron Spectroscopy for Chemical Analysis原理
試料にX線を照射することで最表面から放出される光電子の運動エネルギーを測定し、試料最表面の元素組成や化学状態に関する情報を得る分析手法。
装置概要
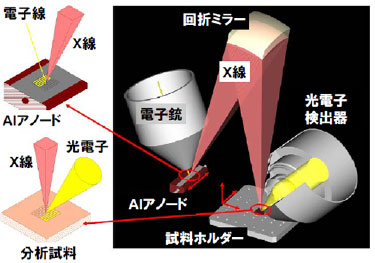
アルバック・ファイ社製PHI QuanteraⅡ
分析可能材料
金属・半導体材料、セラミック・プラスチックなどの絶縁物、電池材料など反応性の高い材料
サンプル制限
試料サイズ:70 mm x 70 mm以下
(非暴露分析時は最大25 mmφ)
高さ制限:20 mm以下
(非暴露分析時は8 mm以下)
試料内高低差:5 mm以内
重さ:200 g以下
特徴
- 極表面(検出深さ約5 nm)の定性・定量分析が可能。
- 最小ビーム径7.5 μmにより、微小領域分析が可能。
- 帯電中和システム搭載により、絶縁物の分析も可能。
- Ar単原子スパッタ銃、Ar-GCIBスパッタ銃装備により、深さ方向分析が可能。
- 角度分解法により、非破壊の深さ方向分析が可能。
- ライン分析・成分マッピングの取得が可能。
- 原子の化学状態により生じる化学シフトを利用して、化学状態解析が可能。
- トランスファーベッセルを用いて、大気非暴露による分析が可能。
分析事例
- 半導体材料の表面汚染、洗浄効果等の定量的評価
- 金属の酸化・硫化・フッ化といった化学状態や高分子の構造変化の評価
- 金属酸化膜や多層構造膜、薄膜構造評価
- 反応性の高い物質(リチウム二次イオン電池材料など)の化学状態評価
XPSを用いた表面分析(ウエハ表面分析)
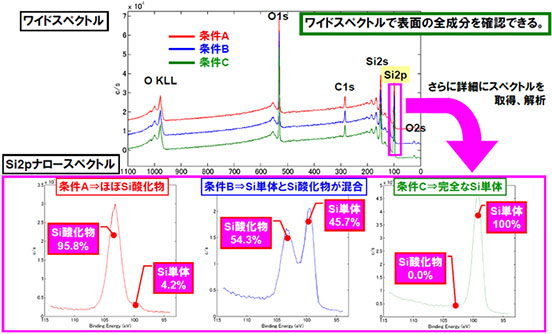
ナロースペクトルでは元素情報のみではなく、各成分の化学状態・存在比の情報まで得られる。
XPSを用いた深さ方向分析(Cuフレーム上のSnめっき表層構造評価)
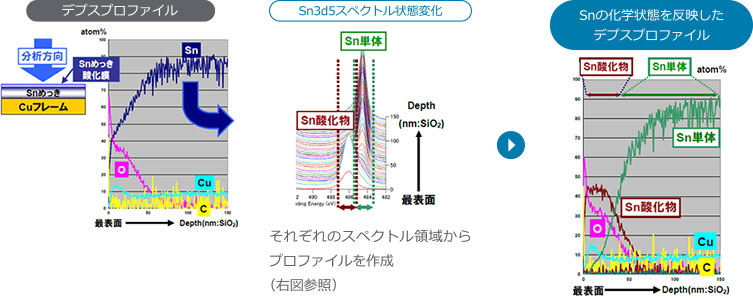
化学状態をデプスプロファイルに反映することで、詳細に層構造を把握することが可能。
飛行時間型二次イオン質量分析法
TOF-SIMS [トフ-シムス]
Time Of Flight-Secondary Ion Mass Spectrometry原理
試料表面に一次イオン(Bi3++)を照射し、発生する二次イオンの検出器までの飛行時間とその個数を測定する。
装置概要

分析可能材料
金属、半導体材料、セラミック、ガラス、プラスチック、紙、液体、揮発性有機成分
サンプル制限
縦x 横:6cm x 6cm以下
厚み:1cm以下
重さ:200g以下
※周囲に凹凸がないこと。
特徴
- 電子中和銃搭載により有機材料・無機材料共に分析可能。
- スパッタガン(Cs,O2, Ar-GCIB)搭載で深さ方向分析が可能。
※GCIB:ガスクラスターイオンビームの略 - 幅広い質量領域のスペクトルを瞬時に取得。(追加解析が可)
- 4cmx4cmまで広域イメージングが可能。【通常の最大分析領域:500x500μm□】
- 有機成分もライブラリーやRef.サンプルから推定が可能。
- 雰囲気遮断システムを搭載。水分・酸素脆弱サンプルの分析が可能。
アプリケーション
表面定性分析・表面イメージング
深さ方向分析・3Dイメージング
広域イメージング
分析事例
表面汚染(付着・残渣・シミ・変色)調査
金属表面のシミ・変色分析
二次電池断面の高空間分解能イメージング
分析の際に必要な情報
サンプルの構造・組成・プロセス上使用されている薬剤名(MSDSシート)
Ref.(比較対象)となるサンプルの情報・着目元素・成分等
表面定性分析 Auめっき表面変色部分析

表面イメージング Auめっき表面変色部分析

深さ方向分析 金属層中のOおよび金属酸化物強度比較

フィールドエミッション電子プローブマイクロアナライザ
FE-EPMA
[エフイーイーピーエムエー]
原理
細く絞った電子線を試料表面に照射することで発生する特性X線の波長を分光結晶を介して測定することで元素分析を行う。
また、二次電子、反射電子を検出することにより試料表面の形状観察も可能である。
装置概要
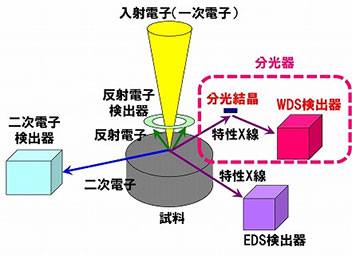
分析可能材料
金属、半導体、セラミック、ガラス、電池材料(大気非暴露)
サンプル制限
縦x 横:最大100mm□
厚み:20mm以下
※傾斜・回転不可
特徴
- 高エネルギー分解能により、EDSの重複ピークへ対応可能。(SnとSbやBaとTiなど)
エネルギー分解能:WDS(10eV程)、EDS(130eV程) - FE電子銃搭載により高空間分解能・大電流条件での分析が可能。
空間分解能:観察条件 3.0nm(30kV, 10pA)、分析条件 50nm(10kV,100nA) - 複数の分光器により、全元素定性分析が可能。(B~U)
- ステージスキャンにより、広範囲元素マッピングが対応可能。(最大90mm□)
- トランスファーベッセルを用いた大気非暴露分析が可能。
- 標準試料を用いた高精度定量分析が可能。
- EDS検出器搭載により、WDSと同時元素マッピングが取得可能。
アプリケーション
像観察:
二次電子像・反射電子像
EDS・WDS:
点分析・線分析
元素マッピング(同時取得可能)
定量分析(WDS)
分析事例
鉛フリーはんだ、金属間化合物などの組成調査
Liイオン電池のバインダー分布評価
材料の添加微量元素解析
分析の際に必要な情報
サンプル構造・構成元素および着目箇所・元素




