Analysis & Evaluation SectionDevice Principle
装置原理形態観察/結晶構造解析-2
集束イオンビーム加工観察装置(マイクロサンプリング)
FIB [エフアイビー]
Focused Ion Beam原理
Gaイオンビームを細く絞り、試料に照射することで加工、成膜、観察が可能。
更にマイクロサンプリングシステムによるTEM・STEM用薄膜試料の作製が可能。
サンプル制限
- 360°回転可能試料台
直径:18mmφ / 厚み:12mm - 大型試料台
30mm 厚み:8mm / X軸稼動範囲:中央±3mm / Y軸稼動範囲:中央±10mm / 回転角度:0°±5°
加工可能材料
金属、半導体材料、セラミック、ガラス、高分子材料等
装置仕様
- 加工電圧:2~40KV
- 像分解能:6nm以下
- 最大ビーム電流:60nA以上
特徴
- マイクロサンプリングによるピンポイント薄膜試料作製が可能。
- 日立SEM・TEM・STEMとのホルダーリンケージ。
- ニードルホルダー使用で側面360°からのFIB加工、STEM観察が可能。
- 大電流(60nA以上)イオンビームによる、短時間で大面積の加工が可能。
- 低加速イオンビームによる低ダメージ薄膜試料作製が可能。
マイクロサンプリングの流れ
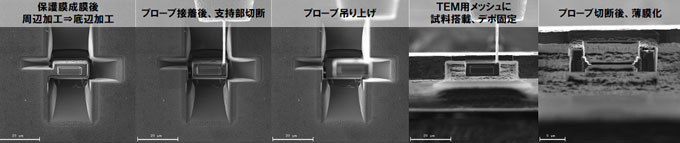
ニードルホルダー

走査型透過電子顕微鏡 / 電子エネルギー損失分光法
STEM [ステム]
Scanning Transmission Electron MicroscopeEELS [イールス]
Electron Energy-Loss Spectroscopy原理
薄片化した試料に電子を照射し、試料中を透過もしくは試料により散乱した電子を利用して、観察・分析を実施する。
装置概要
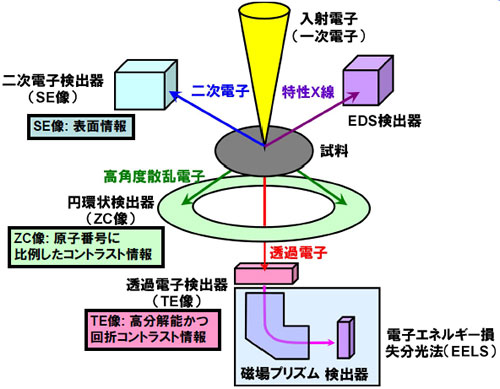
分析できない材料
揮発性材料、磁化を帯びた材料
サンプル制限
直径3mmφ以内、厚み0.5mm以内
観察可能箇所
マイクロサンプリングした薄片
縦x 横x 厚み:8μm x 5μm x 100nm前後
微粉末 ミクロトーム切片
特徴
- 空間分解能0.136nmにより、nmオーダーの測長や微小領域(2nm程)の分析が可能。
- ホルダーリンケージにより、FIB装置間の移動が可能。
- 360度回転ホルダーによりデータ取得および三次元再構築することで、
多様な方向から立体構造の観察が可能(トモグラフィー解析)。 - 雰囲気遮断試料ホルダーを用いて、水分・酸素・窒素脆弱材料の解析が可能。
- クライオホルダーを用いて、冷却(-90~-130℃)制御しながら分析が可能。
- EDXにより、元素(B~U)の同時定性分析や半定量値を算出することが可能。
- EELSにより、軽元素(Liなど)分析や化学結合状態の解析が可能。
アプリケーション
像観察:二次電子像(SE)・散乱電子像(ZC)・透過電子像(TE)・電子回折図形
三次元再構築:トモグラフィー解析
EDX:点分析・線分析・元素マッピング
EELS:点分析・線分析・元素マッピング
分析事例
IC・メモリなどの微細構造解析
Li電池の軽元素分析
分析の際に必要な情報
断面構造および着目箇所、構成元素、予想される化学組成情報。
観察事例(MOSデバイス断面解析)
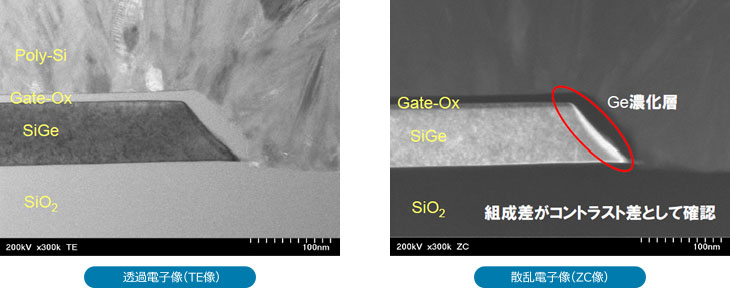
観察モードの特徴
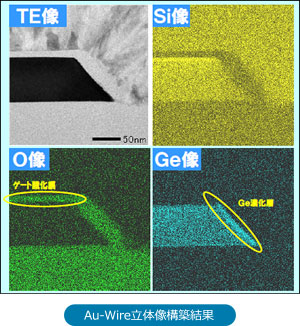
-
TE像
Transmission Electron Image
結晶粒・結晶欠陥の観察に適する。
重い物質が存在する箇所は、透過能が低下するため、コントラストが低下する。 -
ZC像
Z Contrast Image
試料の組成に応じたコントラスト、つまり重たい元素・物質ほど明るく観察され、そのコントラストは原子番号の2乗に比例すると言われている。 -
EDXマッピング像
Energy Dispersive X-ray Spectrometry
電子線を照射した際に励起される特性X線をエネルギー値で分光・検出することにより、照射領域の構成元素を定性・定量する分析手法。点分析、ライン分析および面分析が可能。
分析事例(トモグラフィー解析事例:ホール側壁の微粒子)

分析事例(EELSスペクトル解析事例)
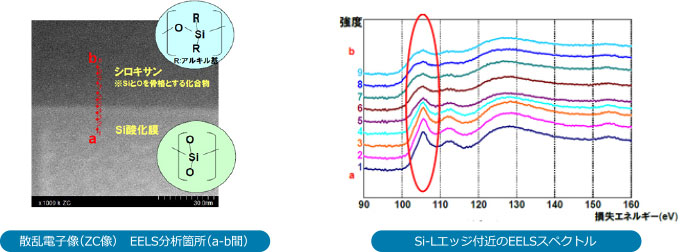
EDXでは、各構成元素「Si」と「O」の情報のみである。EELSスペクトルでは、 構造の違いに起因するピークの変化が確認できる。
観察事例(EELSマッピング解析事例)
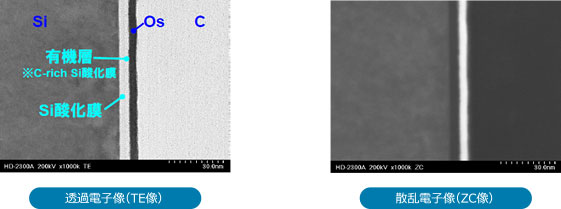
TE像とZC像では、Si酸化膜と有機層の違いを確認できない。

EELS 元素マッピングは、1分以内でデータ取得可能である。
また、観察中に元素マッピングへ信号を切り替えることができ、有機層とSi酸化膜の違いが鮮明に確認できる。
透過電子顕微鏡
TEM [テム]
Transmission Electron Microscope原理
薄くした試料に加速した電子線を照射すると、電子は試料を透過する際に散乱・吸収・回折される。
これら透過した電子を蛍光板やCCDカメラに拡大投影して観察する。
装置概要
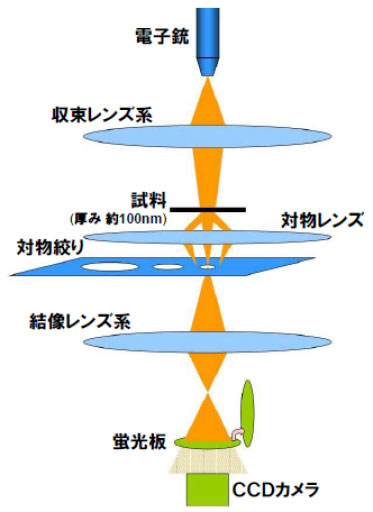
分析可能材料
金属、半導体、セラミック、ガラス
サンプル制限
縦x横:3mmφ
厚み:50μm以下
※観察箇所は50~200nmの薄膜
アプリケーション
像観察:明視野像、暗視野像、高分解能像、電子回折図形
EDX :点分析、元素マッピング
分析事例
半導体デバイスの膜厚・格子欠陥評価
オーミックコンタクト界面の高分解能観察
金属間化合物の同定
分析の際に必要な情報
サンプルの構造・構成元素および着目箇所・元素
特徴
- LaB6電子銃、加速電圧300kVで高分解能観察が可能。
【分解能0.10nm(格子像)、0.18nm(粒子像)】 - 共用ホルダーを用いて、FIB~STEM~イオンミリングのリンケージが可能。
- 特殊制限視野絞りを搭載し、最小15nmφの電子回折図形が取得可能。
- 雰囲気遮断ホルダーを用いて、非暴露でFIB加工→高分解能観察が可能。
- EDX検出器を搭載し、微小領域(10nm)の元素分析が可能。
像観察Au蒸着粒子

電子回折法Au蒸着粒子
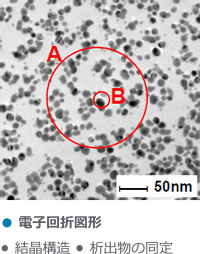

一般的な制限視野回折は多数の粒子の回折図形となるためリング状となるが、
特殊制限視野絞りの適用でおよそ1粒子の回折図形が取得可能。
電子回折法Au蒸着粒子
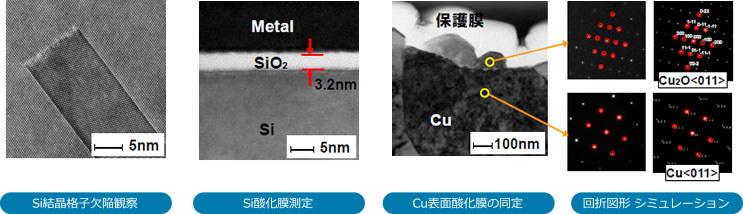
XRD(X線回折:X-ray diffraction)
XRD X線回折
X‐ray diffraction原理
面間隔dの結晶面に波長λの単色X線が、ブラッグの式
nλ=2d sinθ (nは整数)
を満たす角度θで入射させると回折X線が得られる。
入射X線と回折X線は2θの角度をなし、2θを連続的に変化させながらX線を検出することにより、多結晶試料の種々の結晶面から回折X線を得ることができる。
これと標準スペクトル(ASTMカード)との照合により未知試料の同定を行う。
装置概要

試料制限
- 粉末や薄膜などの結晶性試料
分析可能材料
- 最大φ24mm、厚さ2mm
分析の際に必要な情報
- 試料のサイズ(縦横高さ)
- 試料の材質(元素組成)
- 試料の構造等(膜厚等)
アプリケーション
- 薄膜試料の測定
- 微小領域の測定
- LiBのIn-situ測定
- 加熱In-situ測定
特徴
- 物質・化合物の同定が可能。
- 結晶構造解析が可能。
配管内析出物の成分同定





