Analysis & Evaluation SectionDevice Principle
装置原理形態観察/結晶構造解析-1
走査電子顕微鏡/エネルギー分散型X線分析
SEM [セム]
Scanning Electron Microscope原理
加速した電子線を細く絞り試料に照射・走査させ、試料より発生した二次電子や反射電子を画像化して観察する。
装置概要
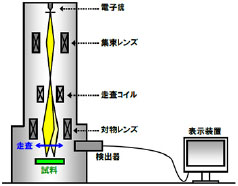
種々の検出器を搭載することによって様々な表面像観察が可能。
観察可能な材料
金属、半導体、セラミック、無機・有機複合材料、磁性体、有機材料等
※ 絶縁試料や樹脂包埋品の観察には表面に導通処理が必要な場合がある。
保有SEMの性能及び特徴
- 試料表面の微細な凹凸情報や組成情報を得ることが可能。
- EDX分析により、任意箇所の構成元素の成分分析が可能。
- 低真空機能により、絶縁試料に対して導通処理不要で観察可能。
- 雰囲気遮断ホルダーにより、大気非暴露でSEM観察・EDX分析が可能。
- 外部電源を接続し、サンプルを動作させながら観察可能。(in-situ観察)
- 大型試料の観察可能。(導入可能な最大試料サイズ:Φ200mm × 高さ75mm)
SEM観察事例(はんだ化合物観察)
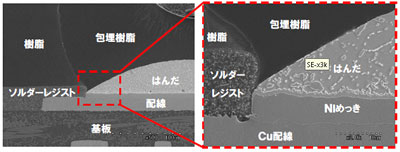
二次電子像
凹凸によるコントラストで、はんだ中の化合物の形状など表面状態を観察できる。
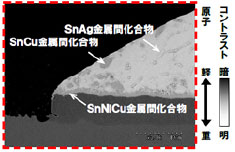
反射電子像
原子の重さによるコントラストではんだなどの元素組成差を観察できる。
EDX [イーディーエックス]
Energy Dispersive X-ray Spectrometry原理
加速した電子線を細く絞り試料に照射し発生した特性X線を検出する。 特性X線は元素に固有のエネルギーを持つことから、構成元素の同定、 分布などを知ることができる。
概要
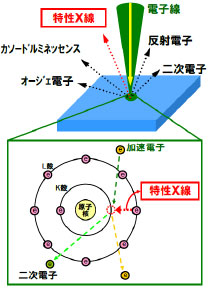
特徴
- 分析スポット径:数μm程度
- 検出元素:5B~92U
- 検出感度:1000ppm程度(= 0.1%)
- 導体だけでなく、絶縁物試料分析可能。
※絶縁試料や樹脂包埋品の観察には表面に導通前処理が必要。
分析アプリケーション
- 定性分析
※ポイント、エリアで指定可能
- 半定量分析
- ライン分析
- マッピング
分析事例
- 異物、析出物、腐食生成物などの成分特定
- 鉛フリーはんだ、金属間化合物などの組成調査
はんだ化合物定性分析(EDX点分析)

マッピング
反射電子像で確認された元素組成差と構成元素の位置関係が、マッピングにより確認できる。

後方散乱電子回折法
EBSD [イービーエスディー]
Electron Backscatter Diffraction原理
傾斜した試料に、電子線を照射することで形成される反射電子線回折パターンを利用し結晶面方位を測定する方法である。
装置概要
-

傾斜試料に電子線を入射することで生じた反射回折により検出スクリーン上にチャンネリングパターンが形成される。
-

各結晶粒がそれぞれの方位に対応したチャンネリングパターンを形成する。
-

パターンの取込マテリアルデータを使用して、コンピュータで指数付け
-

指数付け(方位の決定)をする。
分析可能材料
結晶性を有する金属材料
分析の際に必要な情報
分析目的・サンプルの構造 材料の組成式(Cu6Sn5など)
アプリケーション
結晶方位の測定 EDX併用による相同定
サンプル制限
Φ25mm・高さ1cm程度まで
分析可能な最大領域:1mm x 0.6mm程度
前処理:SEMと同様
構成元素、化合物のマテリアルデータ(結晶方位を決めるための基本データ)がない場合は対応不可。
分析事例
- Alワイヤー接合部のダメージ調査
- Snめっきの配向性評価
- はんだ接合部の金属間化合物の相同定
特徴
- 材料の結晶方位の測定、色相を用いたマッピング像の構築が可能。
- 優先配向、結晶方位のずれを調査することで、材料によっては加工時の力の加わり方を推測することが可能。
- 結晶サイズ(面積、外周の長さ)のグラフ化、平均粒径の算出が可能。
- EDXとの協調機能と、パターンの再構築機能を用いた化合物の相同定が可能。
- 試料への視点を仮想的に変えた場合の方位評価が可能。
評価事例
Snめっきされた電極表面のEBSD分析
-

方位マッピング像
結晶方位を色で表示した像。
-

極点図
測定方位から結晶をプロットしたもの。(110)に優先配向している。
-
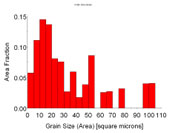
結晶粒径分布
結晶の面積をグラフ表示する。
-

GRAM(※)マップ
局所の結晶方位の変化を示す。材料の変形などの評価に利用する。
※Grain Reference Average Misorientation
Cu電極上のはんだ接合部の金属間化合物の相同定(断面加工→ EBSD相同定)
断面試料を作製し、はんだとCu電極間で生成する化合物1、2をEBSDにて評価した。
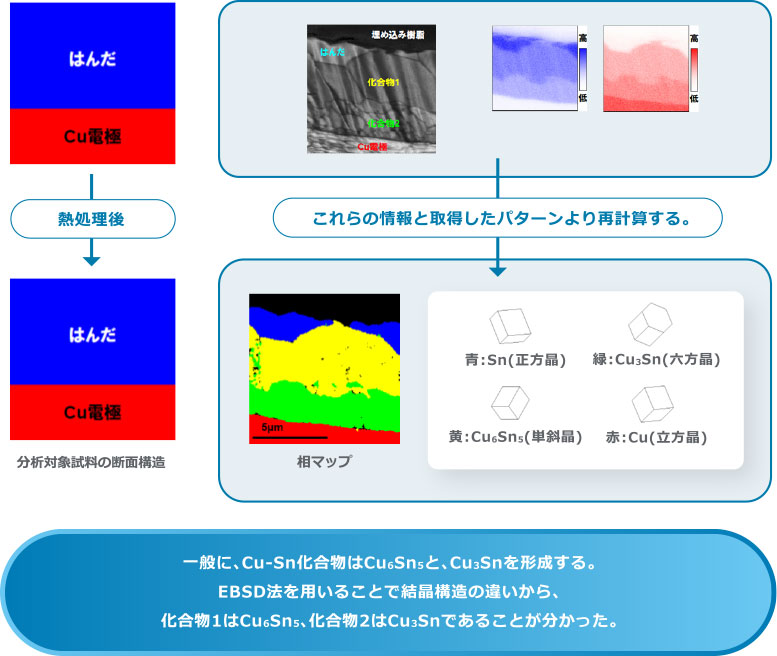
集束イオンビーム装置
FIB [エフアイビー]
Focused Ion Beam原理
イオン銃からGaイオンビームが試料に照射されると、試料表面の原子が弾き出されると共に二次電子が放出される。 この原子が弾き出される現象を利用して試料の垂直断面加工を実施することができる。
また、放出された二次電子を検出することで試料表面の観察をすることができる。
装置概要
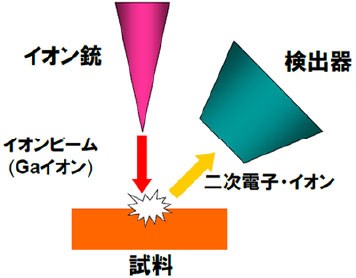
分析可能材料
金属、半導体材料、セラミック、ガラス
試料制限
縦x横x高さ:50mm x 50mm x 12mm以下※試料の凹凸:0.3mm以下
分析の際に必要な情報
試料のサイズ(縦横高さ)、試料の材質、膜構造等
アプリケーション
断面加工・観察、結晶粒観察、配線切断、再配線
分析事例
- 表面パターン異常箇所の断面観察
- 金属断面の結晶粒観察
- IC配線切断/再配線
分析事例
- 通常断面加工は深さ:10μm幅:30μm程度にて可能。
- SIM像で、導電/絶縁性の違いや結晶配向性の違いが明瞭に観察可能。
- 集積回路の配線切断およびWデポジションによる再配線が可能。
- 指定箇所を自動で加工観察することが可能。
※SIM:Scanning Ion Microscope
加工事例
チップ表面パターンの断面加工
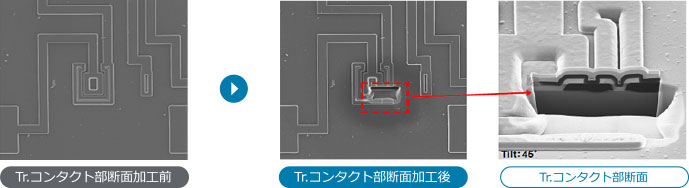
SIM・SEM像観察
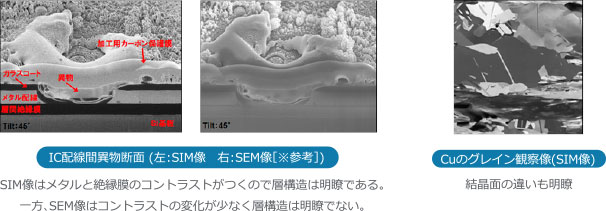
再配線加工
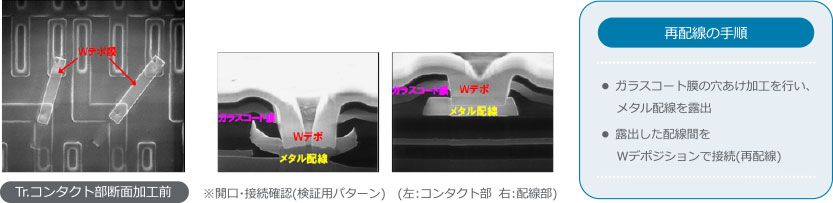
集束イオン/電子ビーム加工観察装置
FIB [エフアイビー]
Focused Ion BeamSEM [セム]
Scanning Electron Microscope原理
断面加工機構(FIB)と表面観察機構(SEM)を一体化した装置。本装置はFIB, SEM各々のビームが58°で交差する構成のため、イオンビームで加工した断面をいつでもSEM観察することができる。
装置概要
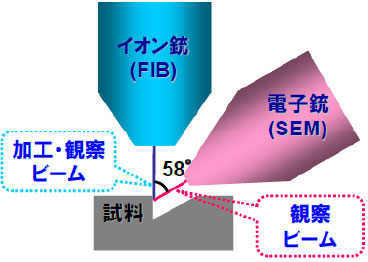
分析可能材料
【FIB】二次電子像分解能:5nm@40kV 【SEM】二次電子像分解能:1.0nm@15kV
サンプル制限
試料サイズ:最大30 mmφ
高さ制限:最大22 mm
特徴
- マイクロサンプリング機能により、特定微小部のTEM用試料作製が可能。
- Mill&Monitorにより、連続断面SEM(BSE)像の撮影が可能。
- EDS分析・EBSD分析により、元素分析・結晶方位解析が可能。
- EBデポジション機能により、ダメージフリーでのデポジションが可能。
- 雰囲気遮断ホルダーにより、大気非暴露でのFIB加工・SEM観察が可能。
※BSE:BackScattered Electron 、EB:Electron Beam
Mill&Monitor機能を用いた連続断面SEM像撮影(W/B接合部観察)
Mill&Monitor機能
FIB加工とSEM像撮影を一定ピッチで繰り返し、連続画像を蓄積する機能
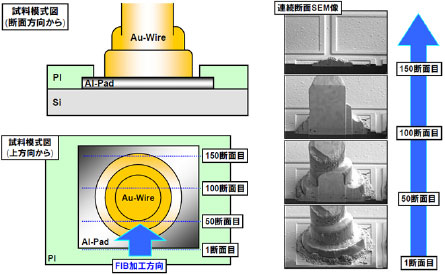
連続断面SEM像からの三次元再構築事例

特徴
- 三次元再構築により、実際のFIB加工方向のみならず、任意角度から断面SEM像が取得可能。
- 立体構造を容易に把握することが可能になるほか、任意領域の体積や表面積の計測も可能。
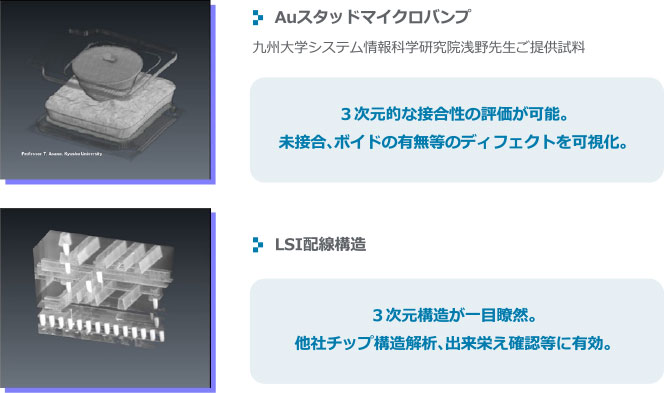
パワーデバイスパッケージ ボンディング直下不具合箇所 三次元解析事例
故障箇所を三次元的に詳細に解析することが出来ます。
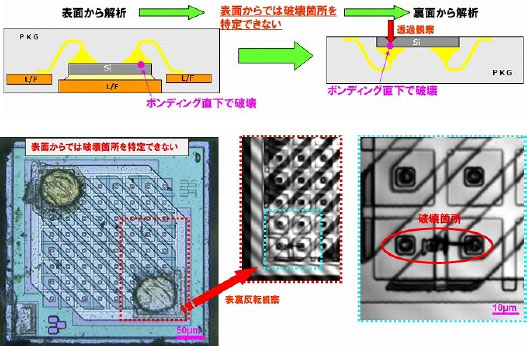
ワイヤー直下での破壊を確認。破壊箇所は特定できても物理解析は非常に困難。 ⇒ Dual-FIBが有効
但し、任意断面の観察だけでは、破壊の形状は不明。 三次元解析が有効。