Analysis & Evaluation SectionDevice Principle
装置原理前処理法
ウルトラミクロトーム
原理
対象試料を樹脂に埋め込み、ダイヤモンドナイフを用い、【かんな】の原理で切削することによって、試料の切片及び断面を作成する前処理装置である。
装置概要
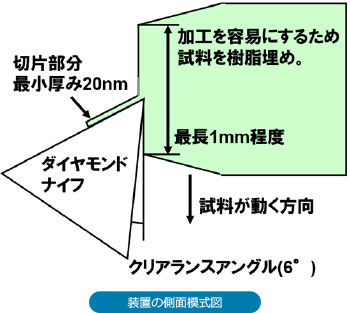
対応可能材料
合成樹脂・金属材料
一部複合材料(プリント基板等)
試料制限
埋め込み可能な最大試料サイズ
縦 x 横 x 厚み:10mm x 5mm x 2mm
最大加工範囲
断面から見て縦 x 横:0.3mm x 1mm
不向きな試料:伸縮するもの(ゴム等)や硬いもの(セラミックス等)
必要な情報
試料の構造・材料組成
特徴
- 100nm以下の超薄切片作成が可能。
- 水を使わないため、水の接触を嫌う試料前処理が可能。
- 熱を加えないので、高温に弱い試料を加工する際も影響が少ない。
- 応用できる分析手法が多い。(TEM、SEM、分光分析など)
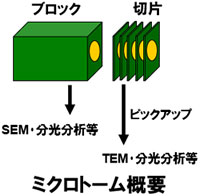
分析事例
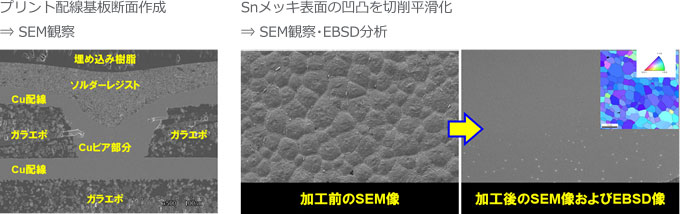
大気非暴露条件下での前処理技術
原理
大気に含まれる水分や酸素・窒素等で変質するサンプルは、大気暴露することなく前処理や装置導入をする必要がある。グローブボックス、トランスファーベッセルを用いることで大気非暴露条件下のサンプル前処理や装置導入、分析を可能にする。
トランスファーベッセル概要
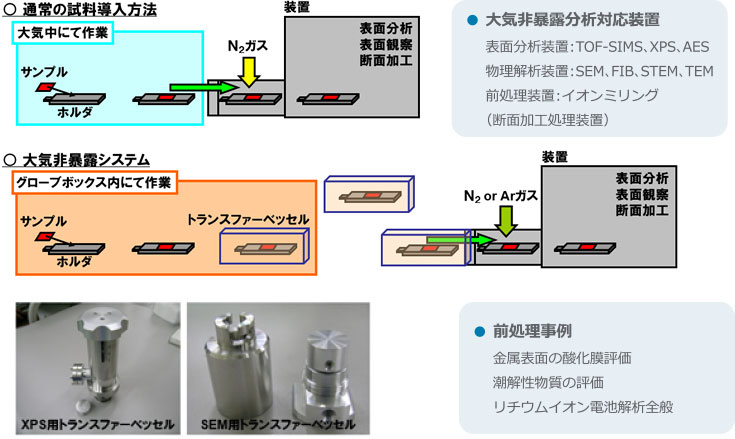
大気非暴露分析の効果 〜二次電池負極(充電状態)〜
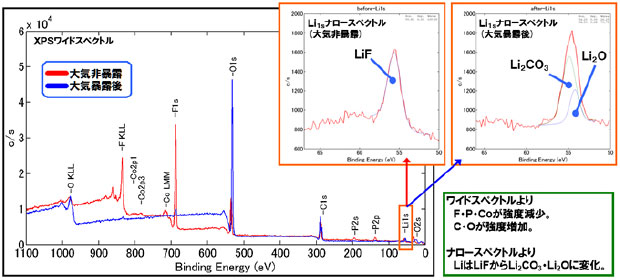
大気非暴露下ではLiF構造であったが、
大気暴露によってLi2O、Li2CO3の様な酸化物、炭酸塩を形成したと推測される。
断面イオンミリング装置
IM [イオンミリング]
Ion Milling原理
サンプル上方に遮蔽版を設置し、Ar+イオンビームを試料に照射する。
スパッタエッチング作用にて遮蔽板から突出した試料を加工し、断面を作成する。
装置概要
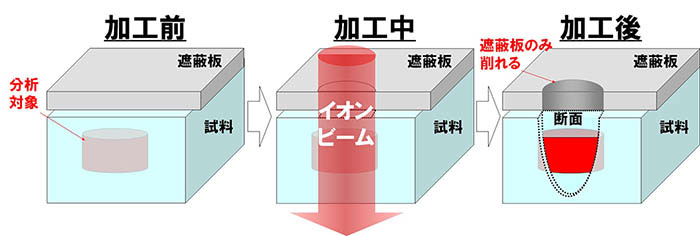
試料を遮蔽板からわずかに突出⇒突出部をイオンビームにより加工し、断面を作成する。
特徴
- 機械加工による破損やひび割れ等のダメージがない。
- FIBよりも広範囲で加工可能。(加工範囲:最大8mm幅×3mm深さ)
- クライオシステムにより熱に脆弱な材料を加工可能。(温度下限:-150℃)
- 大気非暴露システムにより空気や水分に弱い材料を加工可能。
分析の際に必要な情報
- サンプル構造・材料組成・物性
- 加工位置周辺の座標情報
試料サイズ
- 縦×横×厚:20mm×10mm×5mm
加工可能材料
- 金属・半導体材料
- セラミック・ガラス・プラスチック・紙・ゴム
- 上記の混在した複合材料
- 二次電池材料 等
アプリケーション
- 広域断面加工
- クライオ断面加工
- 大気非暴露断面加工
広域断面加工例 ~市販品メモリーチップの断面加工~

広域(最大8mm×3mm)のイオンミリング加工が可能。
クライオ断面加工例 ~PEセパレータのクライオ断面加工~
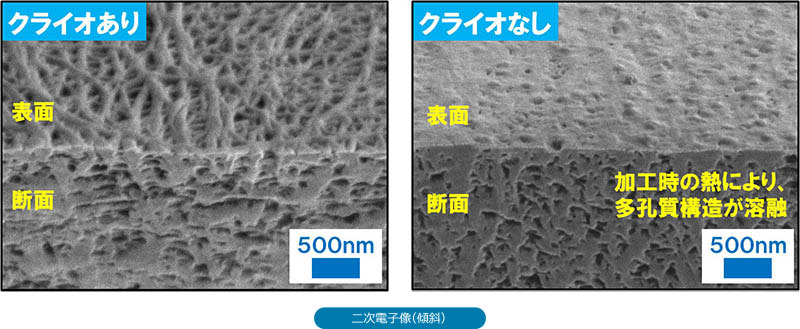
クライオシステムを用いて、熱に弱い樹脂材料を溶融させずに加工可能。
クライオ断面加工例 ~充放電済みグラファイト負極の大気非暴露断面加工~
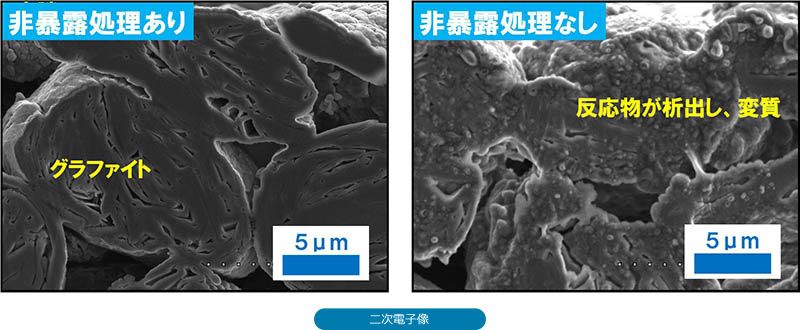
大気非暴露システムを用いて、空気や水分に脆弱な材料も変質させずに加工可能。




