IM[イオンミリング] : Ion Milling
サンプル上方に遮蔽版を設置し、Ar+イオンビームを試料に照射する。
スパッタエッチング作用にて遮蔽板から突出した試料を加工し、断面を作成する。
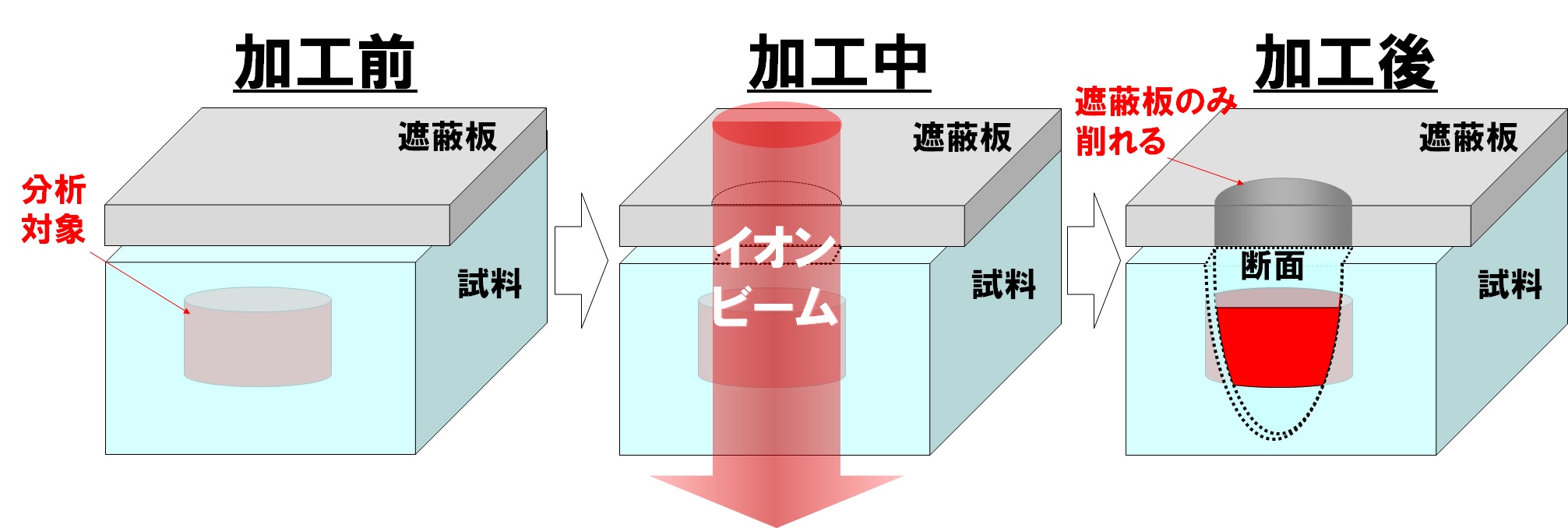
試料を遮蔽板からわずかに突出⇒突出部をイオンビームにより加工し、断面を作成する
|
○ 機械加工による破損やひび割れ等のダメージがない
○ FIBよりも広範囲で加工可能(加工範囲:最大6mm幅×3mm深さ)
○ クライオシステムにより熱に脆弱な材料を加工可能(温度下限:-150℃)
○ 大気非暴露システムにより空気や水分に弱い材料を加工可能
・サンプル構造・材料組成・物性
・加工位置周辺の座標情報
・縦×横×厚:20mm×10mm×5mm
・金属・半導体材料
・セラミック・ガラス・プラスチック・紙・ゴム
・上記の混在した複合材料
・二次電池材料 等
・広域断面加工
・クライオ断面加工
・大気非暴露断面加工
広域断面加工例 ~市販品メモリーチップの断面加工~
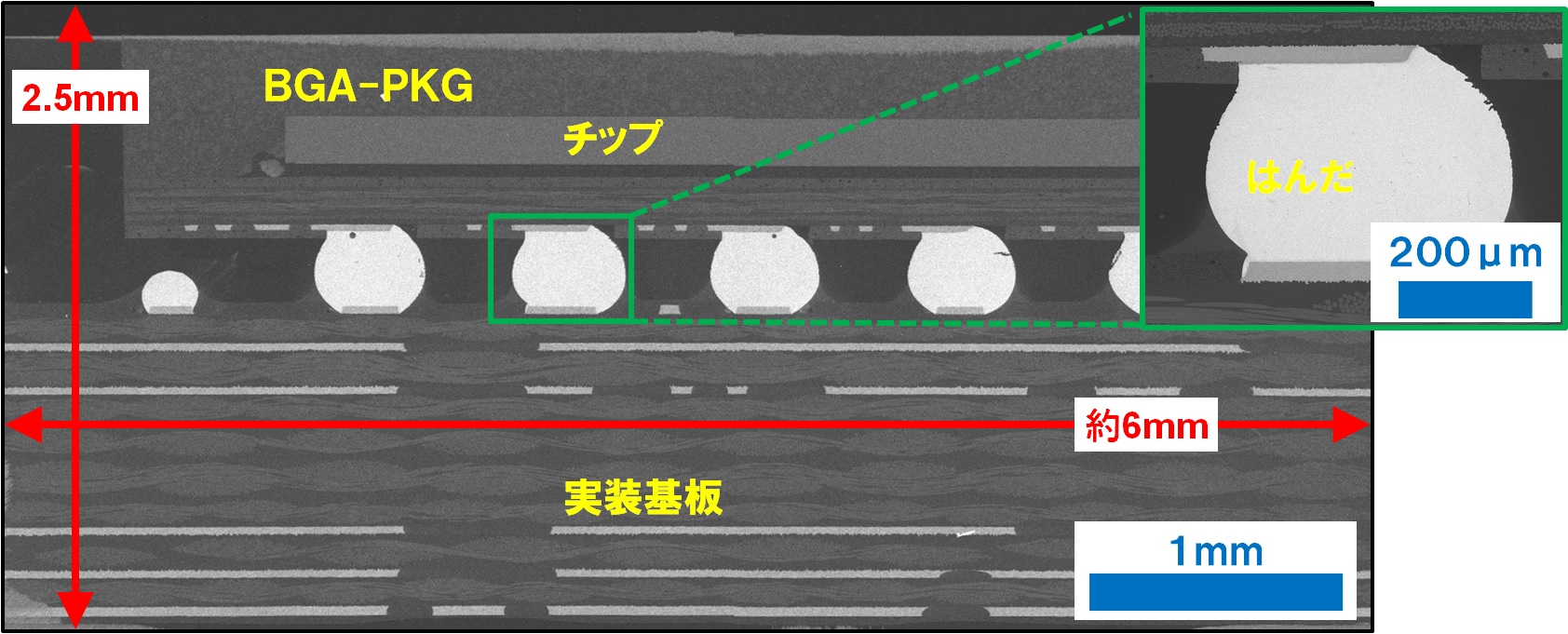
反射電子像
広域(最大6mm×3mm)のイオンミリング加工が可能
|
クライオ断面加工例 ~PEセパレータのクライオ断面加工~
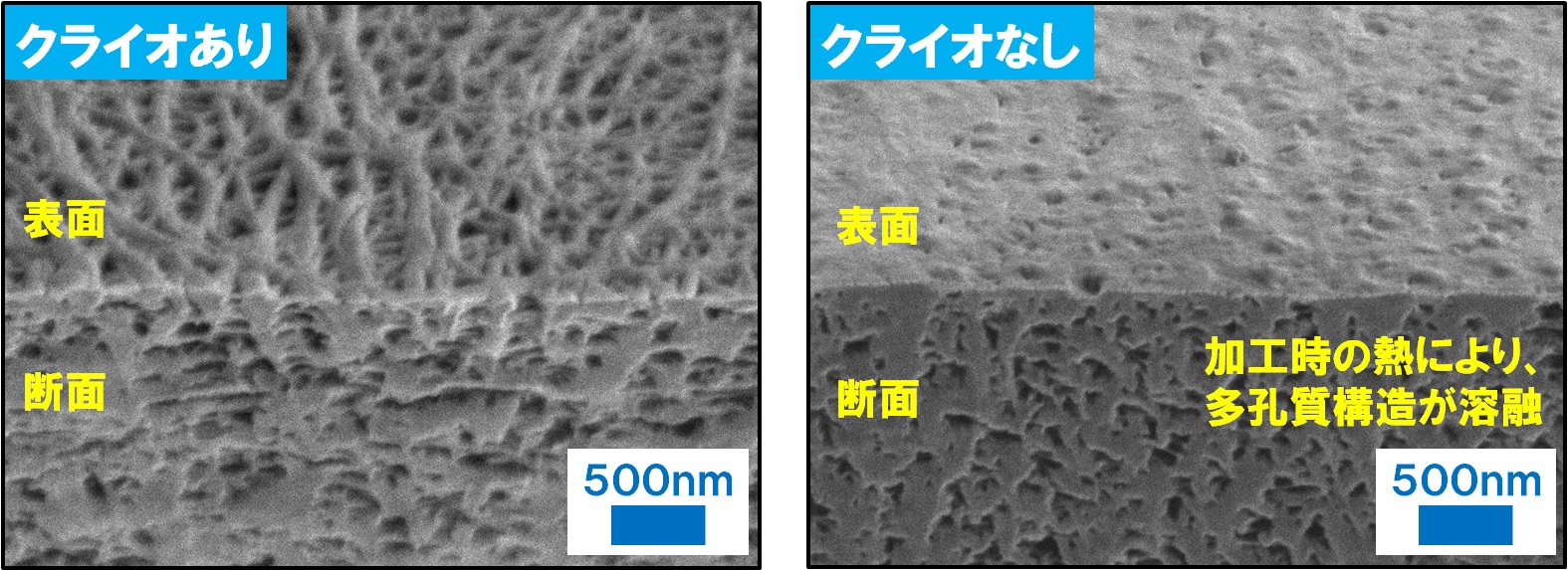
二次電子像(傾斜)
クライオシステムを用いて、熱に弱い樹脂材料を溶融させずに加工可能
|
大気非暴露断面加工例 ~充放電済みグラファイト負極の大気非暴露断面加工~
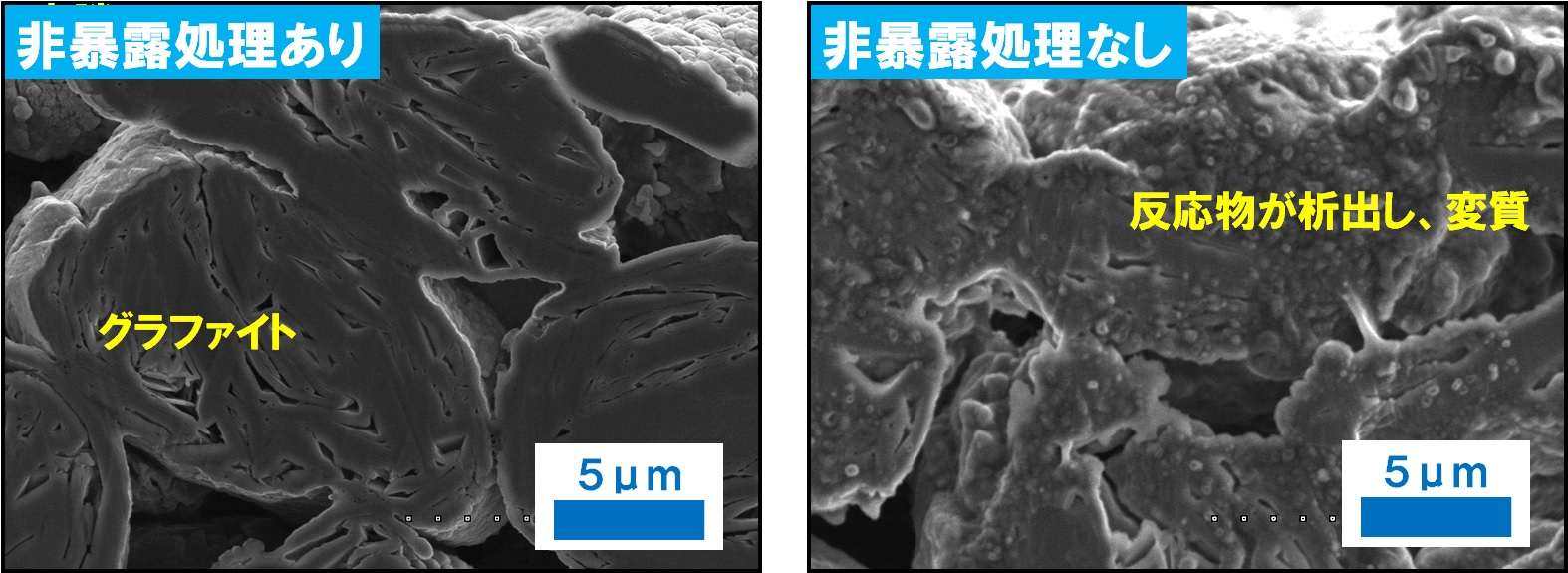
二次電子像
|
大気非暴露システムを用いて、空気や水分に脆弱な材料も変質させずに加工可能
|

|
