SR [エスアール] : Spreading Resistance Profiler
斜研磨したシリコンへ2本のプローブをコンタクトさせて、そのプローブ間の拡がり抵抗を測定し、シリコンの深さ方向の比抵抗(抵抗率)や、キャリア濃度を計算する。
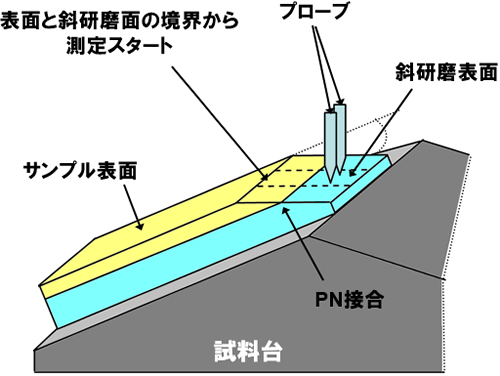
結晶方位:<100>、<111>の単結晶シリコン半導体
縦 x 横 :□ 1.0 mm以上(※)
注入~アニール工程後の不純物拡散
プロファイルの確認等
○ シリコン半導体中の電気的に活性化したキャリア濃度のプロファイルを測定可能。
○ PN接合深さ0.3umより評価可能。
○ 1E+13~1E+20atoms/cm3のキャリア濃度の定量性がある。(1E+15以下の定量性はSRのみ)
・基板の種類:N型、P型
・結晶方位:<100>、<111>
・サンプルの拡散層の構成(P / N / P構造など)
・不純物の種類:リン、砒素、ボロン
※ 0.3mmダイオードのSR測定の実績あり。
特定条件下では(斜研磨角角度5°以上など) 対応可能ですので相談ください。
標準試料の検量線【キャリブレーションカーブ(※)】を用いて比抵抗値、キャリア濃度を算出。
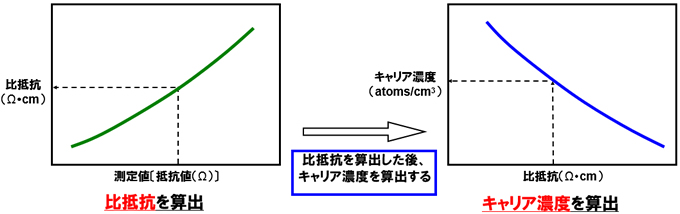
※測定値(抵抗値)は針先の状態等の諸条件で変化するため、測定毎に標準試料の基準抵抗にて補正を実施する。

SR測定により、【比抵抗値】【キャリア濃度】【PN接合深さ】を知ることが可能。

|
