FIB[エフアイビー]: Focused Ion Beam
イオン銃からGaイオンビームが試料に照射されると、試料表面の原子が弾き出されると共に二次電子が放出される。
この原子が弾き出される現象を利用して試料の垂直断面加工を実施することができる。
また、放出された二次電子を検出することで試料表面の観察をすることができる。
金属・半導体材料、セラミック・ガラス
縦x横x高さ:50mm x 50mm x 12mm以下
※試料の凹凸:0.3mm以下
試料のサイズ(縦横高さ)、試料の材質、膜構造等
断面加工・観察、結晶粒観察、配線切断、再配線
表面パターン異常箇所の断面観察
金属断面の結晶粒観察
IC配線切断/再配線
○通常断面加工は深さ:10μm幅:30μm程度にて可能。
○SIM像で、導電/絶縁性の違いや結晶配向性の違いが明瞭に観察可能。
○集積回路の配線切断およびWデポジションによる再配線が可能。
※SIM:Scanning Ion Microscope
チップ表面パターンの断面加工
 |
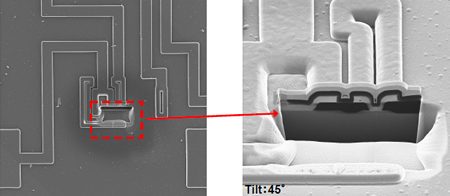 |
Tr.コンタクト部断面加工前 |
Tr.コンタクト部断面加工後 |
Tr.コンタクト部断面 |
SIM・SEM像観察
|
|
|
IC配線間異物断面 (左:SIM像 右:SEM像[※参考])
SIM像はメタルと絶縁膜のコントラストがつくので層構造は明瞭である。
一方、SEM像はコントラストの変化が少なく層構造は明瞭でない。 |
Cuのグレイン観察像(SIM像)
結晶面の違いも明瞭 |
再配線加工
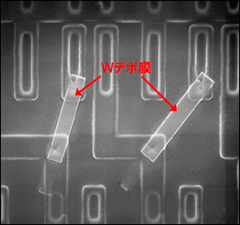 |
【再配線の手順】
・ガラスコート膜の穴あけ加工を行い、メタル配線を露出
・露出した配線間をWデポジションで接続(再配線) |
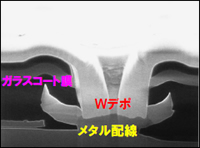 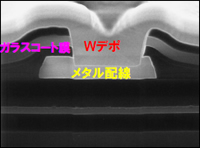 |
Tr.コンタクト部断面加工前 |
※開口・接続確認(検証用パターン)
(左:コンタクト部右:配線部) |

|
